
Полезное:
Как сделать разговор полезным и приятным
Как сделать объемную звезду своими руками
Как сделать то, что делать не хочется?
Как сделать погремушку
Как сделать так чтобы женщины сами знакомились с вами
Как сделать идею коммерческой
Как сделать хорошую растяжку ног?
Как сделать наш разум здоровым?
Как сделать, чтобы люди обманывали меньше
Вопрос 4. Как сделать так, чтобы вас уважали и ценили?
Как сделать лучше себе и другим людям
Как сделать свидание интересным?

Категории:
АрхитектураАстрономияБиологияГеографияГеологияИнформатикаИскусствоИсторияКулинарияКультураМаркетингМатематикаМедицинаМенеджментОхрана трудаПравоПроизводствоПсихологияРелигияСоциологияСпортТехникаФизикаФилософияХимияЭкологияЭкономикаЭлектроника

Классификация контроллеров
|
|
Ускорение научно-технического прогресса и совершенствование хозяйственного механизма тесно связаны с развитием новейшей информационной технологии. Тенденция к большей децентрализации функций управления объективно требует совершенствования непосредственно рабочих мест пользователей, вовлеченных в процесс управления, прежде всего за счет их автоматизации. Очевидно, что без конкретных потребностей (например, в повышении производительности интеллектуального уровня личного труда, выполнение работы быстрее и экономичнее) едва ли возникла бы необходимость в контроллерах. Внедрение контроллеров позволяет реализовать качественно новую информационную технологию, при которой потребитель информации получает и анализирует интересующие его данные непосредственно в процессе общения с ПЭВМ, что обеспечивает комплексную автоматизацию конкретных задач управления.
Работа контроллера помогает лучшему осознанию проблемной ситуации, позволяет частично или полностью решить проблему, подталкивает к оперативному построению модели объекта управления и, тем самым, к грамотному и быстрому принятию решений.
Попытаемся классифицировать контроллеры вообще.Будем определять контроллеры как совокупность методических, схемотехнических и программных средств, обеспечивающих работу пользователей в некоторой предметной области. Все три компонента совершенно необходимы для функционирования контроллера. Методика проектирования контроллера не может не быть связанной с методикой его функционирования, так как функционирование развитого контроллера не предусматривает возможность его развития самими пользователями. Языковые средства микроконтроллеров являются реализацией методических средств с точки зрения конечного пользователя, и дают возможность конечному пользователю производить все необходимые действия.
В состав методических средств должны входить и средства обучения, диапазон которых может быть очень широк: от бумажных инструкций до самообучающихся систем. Их назначение заключается в том, чтобы пользователь научился эффективно работать в условиях автоматизации полного и частного процесса. Если процесс достаточно сложный, а пользователь не имеет специализированные навыков, возможно применение контроллеров, которые позволяют постепенно ввести пользователя в предметную область его автоматизированного процесса. Чем более сложнее проектируется контроллер, тем менее функции могут быть реализованы пользователем.
Следующий аспект методического обеспечения - это реализация заданных функций контроллера, т.е. собственно его функционирования.
Здесь необходимы методики определения цели текущей деятельности, информационной потребности, всевозможных сценариев для описания процессов ее реализации. Эти методические средства могут явным или неявным образом учитываться пользователем. В первом случае пользователь в значительной степени сам планирует свою деятельность.
Языковые средства контроллера необходимы, прежде всего, для однозначного смыслового соответствия действий пользователя и реакции ПЭВМ. Без них невозможен процесс обучения, организация диалога, обнаружение и исправление ошибок. Сложность разработки таких языков заключается в том, что они должны быть преимущественно непроцедурными. Если процедурный язык указывает, как выполняется задаваемое, то непроцедурный - что необходимо выполнить без детализации того, какие действия для этого требуются. Так как конечные пользователи не знают в деталях процесс реализации информационной потребности, чем выше интеллектуальность контроллера, тем больше непроцедурных возможностей должно быть предусмотрено в его языках.
Языки программирования контроллера должны быть пользователь ориентированными, в том числе и профессионально-ориентированными. Это связано с различиями в классификации пользователей. Следует учесть, что использование естественного языка, не может дать сколько-нибудь ощутимых преимуществ из-за необходимости введения через клавиатуру громоздких конструкций ради получения иногда несложных результатов. Кроме того, затраты на построение лексического анализатора для такого контроллера могут сравняться с общими затратами на все остальные составляющие.
Как и во всяком языке, основу языков контроллеров должны составлять заранее определяемые термины, а также описания способов, с помощью которых могут устанавливаться новые термины, заменяя или дополняя существующие. Указанное обстоятельство приводит к необходимости при проектировании контроллера определенным образом классифицировать терминологическую основу контроллеров, т.е. определить все основные синтаксические конструкции языка и семантические отношения между терминами и их совокупностями. В связи с этим может возникнуть необходимость в простейшей классификации контроллеров, например, по возможностям представления данных в некоторых пользовательских режимах обработки: числовые, текстовые и смешанные. Возможности языка во многом определяют и список правил, по которым пользователь может строить формальные конструкции, соответствующие реализации информационной потребности.
1. Теоритическая часть.
Полевой транзистор с изолированным затвором – это полевой транзистор, затвор которого отделен в электрическом отношении от канала слоем диэлектрика. Полевой транзистор с изолированным затвором состоит из пластины полупроводника (подложки) с относительно высоким удельным сопротивлением, в которой созданы две области с противоположным типом электропроводности). На эти области нанесены металлические электроды – исток и сток. Поверхность полупроводника между истоком и стоком покрыта тонким слоем диэлектрика (обычно слоем оксида кремния). На слой диэлектрика нанесен металлический электрод – затвор. Получается структура, состоящая из металла, диэлектрика и полупроводника (рисунок 1). Поэтому полевые транзисторы с изолированным затвором часто называют МДП–транзисторами или МОП–транзисторами (металл–оксид (окисел)–полупроводник).

Рисунок 1 – Топология и основные элементы МОП–транзистора
Технология изготовление МОП-ИМС занимает доминирующее положение среди процессов изготовления полупроводниковых ИМС.
Это объясняется тем, что ИМС на МОП–транзисторах составляют значительную часть основных изделий микроэлектроники различного функционального назначения. Благодаря высокой надежности и большой функциональной сложности МОП-ИМС имеют меньшие геометрические размеры, чем ИМС на биполярных транзисторах. Технология изготовления кристаллов МОП-ИМС во многом схожа с технологией биполярных ИМС. Отличие при этом обусловлено рядом конструктивно-технологических особенностей самих МОП-ИМС.
Различают МОП–транзисторы со встроенным и индуцированным каналом [3]:
В МОП–транзисторах со встроенным каналом есть специальный встроенный канал, проводимость которого модулируется смещением на затворе. В случае канала p типа положительный канал отталкивает дырки из канала (режим обеднения), а отрицательный притягивает (режим обогащения). Соответственно проводимость канала либо уменьшается, либо увеличивается по сравнению с ее значением при нулевом смещении.
МОП–транзисторах с индуцированным каналом проводящий канал возникает между сильнолегированными областями истока и стока и, следовательно, заметный ток стока появляются только при определенной полярности и при определенном значении напряжения на затворе относительно истока (отрицательного при p-канале и положительного при n-канале). Это напряжение называют пороговым.
Первыми в промышленном производстве были p-МОП-ИМС, т.к. изготовление n-МОП-ИМС затруднялось возникновением на поверхности p-Si при термическом оксидировании инверсного n-слоя, который электрически связывает элементы ИМС. Но в настоящее время в производстве преобладают n-канальные ИМС [2].
Транзисторы с электронной проводимостью канала имеют лучшие характеристики, так как подвижность электронов в кремнии значительно превышает подвижность дырок[1].
МДП-ИМС изготавливают по планарной технологии. Наиболее ответственные моменты в технологическом процессе это: создание подзатворного диэлектрика, точное совмещение затвора с каналом и получение структур с малой длиной канала.
Для полевого транзистора с изолированным затвором возможно его сочетание с диодом Шоттки. Диод Шоттки в интегральном исполнении представляет собой контакт полупроводник – металл, на котором образуется так называемый барьер Шоттки. Переходам такого типа, выполненных с учетом определенных требований, присущи такие эффекты как несимметрия вольт–амперной характеристики и наличие барьерной емкости. Для получения подобных переходов металл, наносимый в качестве электрода на поверхность электронного полупроводника, должен иметь работу выхода, меньшую работы выхода полупроводника; для электрода, наносимого на поверхность дырочного полупроводника, требуется металл с большей работой выхода (рисунок 2) [3].

Рисунок 2 – Зонная диаграмма образования бартера Шоттки в месте контакта металла и полупроводника p-типа
В этом случае в полупроводнике на границе с металлом образуется обогащенный основными носителями слой, обеспечивающий высокую проводимость перехода независимо от направления тока.
В целом, изготовление МДП–транзистора с диодом Шоттки не требует введения дополнительных технологических операций.
2. Технологическая часть
2.1рЕЗКА СЛИТКОВ НА ЗАГОТОВКИ

Рисунок 3 – Последовательность технологических операций производства МОП–транзистора с диодом Шоттки.
В исходную пластину методом ионной имплантации внедряются бор для получения подложки p-типа (рисунок 3, а).
Далее на полученную подложку наносится маскирующий слой диоксида кремния (рисунок 3, б).
После этого с помощью фотолитографии и ионной имплантации фосфора формируются области с повышенным содержанием доноров (рисунок 3, в–е).
В последствии выращивается дополнительный слой диоксида кремния. Так как температура на этой стадии высокая, то примеси фосфора в течение этой операции более равномерно распределяются в толще приповерхностного слоя подложки (рисунок 3, ж).
С помощью очередной фотолитографии удаляем оксид кремния в области, разделяющей сток и исток будущего транзистора (рисунок 3, з).
Теперь самая ответственная во всем цикле производства операция – выращивание подзатворного диэлектрика (рисунок 3, и).
Теперь остается сформировать электроды стока, истока и затвора, а также переход Шоттки. Сейчас упрощенно покажем эту металлизацию (рисунок 3, к–м), а далее более подробно рассмотрим принципы ее формирования (раздел 2.4.5).
2.2Выбор класса производственных помещений
За основу современных требований по классам чистоты чистых помещений и чистых зон берутся нормы, определенные в Федеральном стандарте США FS209E [4]. Подготовленный проект Российского стандарта гармонизован с этим стандартом США.
Критерий чистоты – это отсутствие или минимальное число частиц загрязнений, которые находясь на поверхности пластины могут вызывать либо дефекты в выращиваемых слоях, либо становиться причиной коротких замыканий соседних близко расположенных элементов ИС.
Таблица 1–Классы чистоты по взвешенным в воздухе частицам для чистых помещений
| Класс чистоты | Предельно допустимая счетная концентрация частиц N (шт/м3) размером равным и превышающим (мкм) | ||||
| 0,1 | 0,2 | 0,3 | 0,5 | 1,0 | |
| Класс 1 ISO | – | – | – | ||
| Класс 2 ISO | – | ||||
| Класс 3 ISO | |||||
| Класс 4 ISO | |||||
| Класс 5 ISO | |||||
| Класс 6 ISO | |||||
| Класс 7 ISO | – | – | – | ||
| Класс 8 ISO | – | – | – | ||
| Класс 9 ISO | – | – | – |
Количественный критерий – критический размер частиц – одна треть от минимального геометрического горизонтального размера элемента ИС:

Таким образом, можно выбирать чистое помещение, соответствующее классам чистоты от ISO 1 до ISO 6. Ориентируясь также на стоимость, выбираем класс чистоты ISO 2, для которого максимально допустимая концентрация взвешенных в воздухе частиц, равных или больших чем рассматриваемый размер 0,2 мкм (число частиц в 1м3 воздуха) составляет:

где N – номер класса чистоты ISO; D – рассматриваемый размер частиц, мкм.
2.3 Основные материалы и реактивы
В течение многих лет основным полупроводниковым материалом, который используется для изготовления интегральных схем, остается монокристаллический кремний. Пластины кремния являются той основой, в поверхностных слоях которой создаются полупроводниковые области с заданными электрофизическими характеристиками. На поверхности кремния формируются диэлектрические слои окислением самого полупроводникового материала или нанесением диэлектриков из внешних источников; образуются структуры многослойной металлизации, защитные, стабилизирующие слои и так далее.
Требования к пластинам кремния детально отработаны, существует целый каталог международных стандартов ассоциации SEMI, в то же время продолжается постоянное повышение требований к кремнию, что связано с постоянным стремлением к снижению себестоимости конечного продукта – интегральных схем.
Ниже приведены некоторые геометрические характеристики пластин кремния в соответствии с техническими условиями ЕТО.035.124ТУ, ЕТО.035.206ТУ, ЕТО.035.217ТУ, ЕТО.035.240ТУ, ЕТО.035.578ТУ, ПБЦО.032.015ТУ [5].
Диаметр пластины 100мм.
Ориентация кремниевой подложки (100) имеет преимущество по сравнению с (111), заключающееся с более высокой подвижности электронов, обусловленной низкой плотностью поверхностных состояний на границе кремний–диэлектрик.
Толщина пластины 500 мкм.
Разброс значений толщины в партии ±10 мкм.
Разброс значений толщины по пластине ±12 мкм.
Прогиб 20 мкм.
Отклонение от плоскостности ±5 мкм.
Количество светящихся точек, менее 10
Высокие требования по примесям и механическим частицам предъявляются к деионизованной воде. В таблице 2 приведены выписки из руководящего материала международной ассоциации SEMI с указанием рекомендуемых параметров сверхчистой воды для производства полупроводниковых интегральных схем с минимальным размером элемента 0,8–1,2 мкм. Соответствующая индексация жидких реагентов по стандартам SEMI записывается как SEMI C7.
Значение параметра удельного электрического сопротивления воды должно быть близко к теоретической величине 18,2 МОм·см.
Таблица 2 – Рекомендуемые параметры деионизованной воды, используемой для процессов полупроводниковой технологии
| Содержание окисляемой органики, ppb | <10 |
| Содержание тяжелых металлов, ppb | <3 |
| Частиц/литр 0,1–0,2U 0,2–0,3U 0,3–0,5U >0,5U | <1500 <800 <50 <1 |
| Бактерии/100мл | <5 |
| SiO2 | |
| Содержание ионов, ppb Na+ K+ Cl– Br– NO3– SO42– Общее количество ионов, ppb | 0,025 0,05 0,025 0,05 0,05 0,2 <0.2 |
| Сухой остаток, ppm | <0,05 |
Кроме параметров, указанных в таблице, в рекомендациях SEMI приведены данные по наличию следов ряда металлов в воде. Анализ проводится на содержание следующих металлов: Li, Na, K, Mg, Ca, Sr, Ba, B, Al, Cr, Mn, Fe, Ni, Cu, Zn, Pb.
Для воды градации SEMI C7 для всех без исключения указанных элементов допустимая концентрация следов лежит в пределах от 0,001 до 0,005 ppb.
Уровень чистоты жидких химических реактивов, применяемых в производстве интегральных схем, определяется серией международных стандартов и имеет различные градации в соответствии с уровнем сложности интегральных схем.
«Grade 2» имеет обозначение стандарта, начинающееся с символов SEMI C7. Реактивы, имеющие уровень чистоты «Grade 2», используются при изготовлении интегральных схем с проектными нормами в диапазоне 0,8-1,2 мкм, что соответствует требованию задания. В реактивах градации «Grade 2» контролируются посторонние частицы размером 0,5 мкм и выше. Практически во всей номенклатуре реактивов максимальная норма – 25 частиц в 1 мл реактива. В спецификациях на такие реактивы содержание следов металлов указывается 5–10 ppb.
Помимо стандартов для химических реактивов повышенной чистоты разработаны спецификации в виде руководящих материалов.
В соответствии с ними сформированы три уровня (яруса) требований к чистоте: A, B, C (в английском написании – Tier A, Tier B, Tier C). Уровню А соответствуют требования стандарта SEMI C7. Соответственно, реактивы для данного технологического процесса должны отвечать Tier A (ярус A).
В технологии изготовления интегральных схем исключительную роль играют газы.
Практически все технологические процессы проходят в газовой среде и проблема создания производства полупроводниковых приборов «без загрязнений» – это в большой степени проблема чистоты газов. Различают два типа газовых сред: газы – носители и газы химических реакций в технологических процессах. Парциальное давление газов-носителей, как правило, высокое, в связи с чем их чистота с учетом высокой концентрации в рабочей газовой среде особенно критична в технологии.
2.4 Основные технологические операции
2.4.1 Очистка подложки
Понятно, что на любой подложке в каком-то количестве присутствуют загрязнения. Это могут быть частицы пыли, молекулы различных веществ, как неорганических, так и органических. Пылеобразные частицы удаляются либо механической кистевой, либо ультразвуковой отмывкой. Применяются методы с использованием центробежных струй. Процедура химической очистки обычно проводится после ликвидации неорганических молекул и атомов, и заключается в удалении органических загрязнений.
Обычная процедура очистки выполняется в смеси H2O–H2O2–NH4OH, которая обеспечивает удаление органических соединений за счет сольватирующего действия гидроксида аммония и окисляющего действия перекиси водорода. Для удаления тяжелых металлов используют раствор H2O–H2O2–HCl. Подобная очистка подложек проводится при температуре ~80ºС в течение 10–20 минут, после чего осуществляется их отмывка и сушка.
2.4.2 Термическое окисление
Под окислением полупроводников понимают процесс их взаимодействия с окисляющими агентами: кислородом, водой, озоном и т.д.
Слой двуокиси кремния формируется обычно на кремниевой пластине за счет химического взаимодействия в приповерхностной области полупроводника атомов кремния и кислорода. Кислород содержится в окислительной среде, с которой контактирует поверхность кремниевой подложки, нагретой в печи до температуры 900 – 1200 °С. Окислительной средой может быть сухой или влажный кислород. Схематично вид установки показан на рисунке 4 (в современных установках пластины в подложкодержателе располагаются вертикально)[6].

Рисунок 4–Схема установки процесса термического окисления
Требования к оборудованию:
1) контролируемая с точностью до 1 градуса температура подложкодержателя;
2) обеспечение плавного повышения и понижения температуры в реакторе (двухстадийный нагрев);
3) отсутствие посторонних частиц в реакторе (подложкодержатель сначала вводится в трубу реактора, а затем опускается на дно);
4) отсутствие посторонних примесей, в частности, ионов натрия на внутренней поверхности реактора (с целью их удаления проводится предварительная продувка трубы реактора хлором);
5) обеспечение введения кремниевых пластин в реактор сразу после их химической очистки.
Химическая реакция, идущая на поверхности кремниевой пластины, соответствует одному из следующих уравнений:
окисление в атмосфере сухого кислорода (сухое окисление): SiТВ+ O2 = SiO2;
окисление в парах воды (влажное окисление): SiТВ+2H2O = SiO2 + 2H2;
термическое окисление в присутствии хлора (хлорное окисление);
окисление в парах воды при повышенных температуре и давлении (гидротермальное окисление).
При одной и той же температуре коэффициент диффузии воды в диоксиде кремния существенно выше коэффициента диффузии кислорода. Этим объясняются высокие скорости роста оксида во влажном кислороде. Выращивание пленок только во влажном кислороде не применяется из-за плохого качества оксида. Более качественные пленки получаются в сухом кислороде, но скорость их роста слишком мала.
Для маскирования при локальных обработках оксидирование ведут в режиме сухой–влажный–сухой кислород. Для формирования подзатворного диэлектрика МОП–структур применяют сухой кислород, т.к. пленки получаются более качественные.
2.4.3 Литографические процессы
Основное назначение литографии при изготовлении структур микросхем – получение на поверхности пластин контактных масок с окнами, соответствующими топологии формируемых технологических слоев, и дальнейшая передача топологии (рисунка) с маски на материал данного слоя. Литография представляет собой сложный технологический процесс, основанный на использовании явлений, происходящих в резистах при актиничном облучении.
Резисты, растворимость которых в проявителе увеличивается после облучения, называются позитивными. Негативные резисты после облучения становятся практически нерастворимыми в проявителе.
Стандартно в электронной промышленности применяется оптическая литография – фотолитография (рисунок 5), – для которой применяют фоторезисты, чувствительные к актиничному излучению с длиной волны от 200 до 450 нм. Фоторезисты представляют собой сложные полимерные композиции, в составе которых имеются фоточувствительные и пленкообразующие компоненты, растворители и специальные добавки.
В проекте используется позитивный высококачественный и стабильный фоторезист ФП–20Ф, предназначенный для реализации контактных и проекционных фотолитографических процессов в производстве полупроводниковых приборов и интегральных схем. В соответствии с этим для травления можно применять слабый водный раствор KOH или NaOH.
Наиболее оптимальный способ нанесения фоторезиста – центрифугирование. Подложка закрепляется на горизонтальной центрифуге. На подложку наносится 1-5 мл фоторезиста (в зависимости от размеров подложки). Центрифуга приводится во вращение до скорости 1000-3000 об/мин (в зависимости от марки фоторезиста).
Вращение продолжается 1-2 мин до формирования пленки фоторезиста, растворитель при этом испаряется.

Рисунок 5 – Схема основных операций фотолитографического процесса
Существует несколько способов экспонирования, в проекте будем использовать бесконтактный (рисунок 6). Проекционная печать позволяет полностью исключить повреждения поверхности шаблона. Изображение топологического рисунка шаблона проецируется на покрытую резистом пластинку, которая расположена на расстоянии нескольких сантиметров от шаблона.

1- источник света; 2- оптическая система; 3- шаблон;
4- фоторезист; 5- кремниевая пластина.
Рисунок 6–Схема проекционной печати[6]
Для достижения высокого разрешения отображается только небольшая часть рисунка шаблона. Это небольшая отражаемая область сканируется или перемещается по поверхности пластины. В сканирующих проекционных устройствах печати шаблон и пластина синхронно перемещаются.
При сушке фоторезиста очень важно подобрать нужные температуру и время. Сушка фоторезиста будет осуществляться наиболее распространенным способом – ИК-излучением. При этом растворитель удаляется равномерно по толщине слоя резиста и не происходит его уплотнения, а время сушки понижается до нескольких минут.
2.4.4 Ионная имплантация
Легирование полупроводниковых материалов с целью получения заданных электрофизических параметров слоев при формировании определенной геометрической структуры ИС остается важнейшей технологической задачей.
Существует два вида легирования: диффузионное (включает в себя стадии загонки примеси и последующей разгонки) и ионное.
Наиболее распространенным является ионная имплантация (ионное легирование) как процесс внедрения в мишень ионизованных атомов с энергией, достаточной для проникновения в ее приповерхностные области (рисунок 7). Этот способ отличается универсальностью (можно вводить любые примеси в любое твердое тело), чистотой и точностью процесса легирования (практически исключается попадание неконтролируемых примесей) и низкими температурами процесса.

1 - источник ионов; 2 - масс-спектрометр; 3 - диафрагма; 4 - источник высокого напряжения; 5 - ускоряющая трубка; 6 - линзы; 7 - источник питания линз; 8 - система отклонения луча по вертикали и система отключения луча; 9 - система отклонения луча по горизонтали; 10 - мишень для поглощения нейтральных частиц; 11 - подложка.
Рисунок 7 – Схема установки ионного легирования [6]
При ионной имплантации проявляется ряд нежелательных эффектов, таких как эффект каналирования, аморфизация приповерхностного слоя подложки, образование радиационных дефектов.
Эффект каналирования наблюдается при попадании иона в свободное пространство между рядами атомов. Такой ион постепенно теряет энергию за счет слабых скользящих столкновений со стенками канала и, в конце концов, покидает эту область. Расстояние, проходимое ионом в канале, может в несколько раз превышать длину пробега иона в аморфной мишени, а значит профиль распределения примеси получается неравномерным.
При внедрении ионов в кремниевую кристаллическую подложку они подвергаются электронным и ядерным столкновениям, однако, только ядерные взаимодействия приводят к смещению атомов кремния. Легкие и тяжелые ионы по-разному взаимодействуют с подложкой.
Легкие ионы при внедрении в мишень первоначально испытывают в основном электронное торможение. На профиле распределения смещенных атомов по глубине подложки существует скрытый максимум концентрации. При внедрении тяжелых ионов они сразу начинают сильно тормозиться атомами кремния.
Тяжелые ионы смещают большое количество атомов мишени из узлов кристаллической решетки вблизи поверхности подложки. На окончательном профиле распределение плотности радиационных дефектов, который повторяет распределение длин пробега выбитых атомов кремния, существует широкий скрытый пик. Например, легкие ионы 11B испытывают в основном электронное торможение, тяжелые ионы 31P или 75As – тормозятся атомами кремния.
В связи с этим после проведения ионного легирования необходимо провести постимплантационный отжиг, чтобы восстановить приповерхностную область мишени.
Области стока и истока будем формировать внедрением фосфора, а для получения подложки p-типа исходную подложку будем легировать бором.
2.4.5 Металлизация
Металлизация завершает процесс формирования полупроводниковых структур. Для каждой ИМС металлизацию желательно выполнять из одного материала. Процесс металлизации заключается в реализации межкомпонентных соединений с низким сопротивлением и создании контактов с низким сопротивлением к высоколегированным областям p- и n-типа и слоям поликристаллического кремния.
Согласно заданию на курсовой проект необходимо сформировать 3 слоя металлизации. Такая металлизация полнее отвечает предъявляемым требованиям, но менее технологична, т.к. содержит не один слой металла.
В качестве первого слоя металлизации на оксиде чаще всего используют тугоплавкие металлы, особенно молибден и ванадий. Имя большую проводимость, чем другие тугоплавкие металлы, они отличаются высокой стабильностью, хорошей адгезией, легко травятся при фотолитографии. Должны обладать малой растворимостью в материале подложки и создавать хороший омический контакт с полупроводником, небольшим пороговым напряжением. Вторым слоем обычно служит алюминий, а в особо ответственных устройствах – золото. Он должен быть высокопроводящим.
Последний по порядку нанесения слой металлизации, называемый проводящим слоем, должен иметь хорошую электропроводность и обеспечивать качественное подсоединение контактных площадок к выводам корпуса. Для проводящих слоев применяются медь, алюминий, золото.
Существует множество методов получения металлических пленок. Получение качественных незагрязненных пленок методом термовакуумного напыления сложно[2]. Пленки алюминия, полученные термовакуумным испарением, обладают большой неравномерностью размеров зерен и высоко концентрацией внутри зерен. Их последующая термообработка приводит к миграции атомов металла и скоплению их вокруг крупных частиц с образованием высоких бугорков. Получение рисунков на таких пленках фотолитографией приводит к большим неровностям краев вследствие анизотропии травления по границам зерен. Поэтому для получения линий металлизации очень малой ширины отказываются от термовакуумных процессов [1]. Способ химического осаждения пленок из парогазовой смеси чаще применяется в лабораторных условиях. Электронно-лучевое несмотря на то, что усложняет конструкцию установки, позволяют снизить загрязнение пленок и повысить производительность процесса (рисунок 8). Оптимальная скорость роста пленки составляет 0.5 мкм/мин. С помощью данного метода наносят пленки алюминия и его сплавов, а также Si, Pd, Au, Ti, Mo, Pt, W.
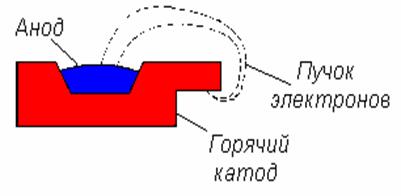
Рисунок 8 – Схема процесса электронно-лучевого испарения [6]
К преимуществам электронно-лучевого испарения относятся:
- возможность использования больших по массе источников (не требуется перезагрузка при нанесении толстых пленок);
- возможность последовательного нанесения различных пленок из соседних источников, расположенных в одной камере;
- высокая скорость роста пленок;
- возможность напыления тугоплавких материалов.
Барьер Шоттки по выполняемым функциям не относится к металлизации, но по технологии формирования его можно отнести к металлизации, т.к. она аналогична получению омических контактов к активным областям. Важнейшим этапом формирования барьеров Шоттки является выбор пары металл – полупроводник и оптимальных режимов.
Итак, для контактного слоя применим силицид платины, который будет нанесен методом электронно-лучевого испарения путем совместного испарения из двух источников. Барьер Шоттки обеспечит сплав титана и вольфрама, нанесенный на кремний тем же методом. По сути, этот сплав будет аналогичен сильнолегированной области. Для проводящего слоя применим алюминий, также нанесенный методом электронно-лучевого испарения.
2.4.6 Межслойная изоляция
Многоуровневая металлизация применяется для БИС и СБИС. Увеличение числа элементов увеличивает и площадь межэлементных соединений, поэтому их размещают в несколько уровней, разделенных изолирующими слоями и соединенными между собой в нужных местах.
Изолирующие диэлектрические пленки должны иметь высокое напряжение пробоя, низкие диэлектрическую постоянную и потери, минимальное химическое взаимодействие с прилегающими пленками, низкий уровень механических напряжений, низкую плотность связанного электрического заряда, высокую химическую стабильность и технологичность при получении пленок и создании рисунка. Недопустимым является наличие сквозных микроотверстий, которые могут привести к короткому замыканию между слоями металлизации.
Технология многоуровневой металлизации включает формирование первого уровня металлизации, получение изолирующего слоя с последующим вскрытием межуровневых контактных окон, формирование второго слоя металлизации и т.д.
Многие серийно выпускаемые ИМС изготавливаются на основе алюминиевой металлизации с изолирующими слоями SiO2 [2]. Пленки диоксида кремния могут осаждаться как с легирующими добавками, так и без них. Важнейший параметр при осаждении SiO2 – воспроизводимость рельефа (рисунок 9).

Рисунок 9–Конформное воспроизведение. Толщина пленки на стенках ступеньки не отличается от толщины на дне и поверхности. Обусловлено быстрой поверхностной миграцией [6]
В данном проекте в качестве изолирующей пленки между многоуровневой металлизацией используется нелегированный диоксид кремния, наносимый методом химического осаждения из газовой фазы (рисунок 10). Последний основан на использовании явления пиролиза или химических реакций при формировании пленок изолирующего материала.

Рисунок 10 – Установка формирования пленок методом химического осаждения из газовой фазы при нормальном давлении [6]
В качестве химически активного газа применяют моносилан SiH4 и кислород, а в качестве буферного газа – азот.
SiH4 + O2 → SiO2 + 2H2
Такой процесс является самым низкотемпературным для получения качественных диэлектрических слоев SiO2 (реакцию проводят в диапазоне температур 200–400ºС). Недостатком является горючесть и взрывоопасность силана. Пленки формируются очень чистыми, но из-за низких температур получаются неплотными. Во избежание этого нужно строго регулировать концентрацию силана в газовой фазе и подавать его непосредственно на поверхности пластин, предотвращая рост SiO2 в газовой фазе [1].
3. нженерно-экономические расчеты
Date: 2015-11-14; view: 798; Нарушение авторских прав