| |  Рис. 2. Распределение Ферми (m – уровень Ферми)
Вспомним теперь, что уровни Е2 и Е1 разделены запрещенной зоной и находятся соответственно в зоне проводимости и в валентной зоне. Неравновесные носители, т. е. неравновесные электроны в зоне проводимости и дырки в валентной зоне, создаваемые каким-то источником накачки, обладают конечными временами жизни в зонах. На протяжении этого времени термодинамическое равновесие не соблюдается, и, следовательно, единого уровня Ферми для всей системы в целом не существует. Однако если в электронном и дырочном газах в отдельности за время, меньшее времени жизни носителей в зонах, устанавливается свое квазиравновесное состояние фермиевского типа, но с одной и той же температурой для всей системы, а равновесие между этими газами отсутствует, то можно ввести так называемые квазиуровни Ферми отдельно для электронов в зоне проводимости mn и дырок в валентной зоне mp.
Допустимость введения отдельных квазиравновесных функций распределения для дырок и электронов в валентной зоне и в зоне проводимости соответственно априорно не очевидна. Она оправдывается тем, что по крайней мере в нескольких полупроводниках время термализации электронов в пределах зоны (0.1 пс) на три – четыре порядка меньше характерного времени межзонной термализации (1–10 нс).
Вернемся к условию инверсии (10). Представив в соответствии с проведенным выше обсуждением f(E2) и f(E1) в виде
Рис. 2. Распределение Ферми (m – уровень Ферми)
Вспомним теперь, что уровни Е2 и Е1 разделены запрещенной зоной и находятся соответственно в зоне проводимости и в валентной зоне. Неравновесные носители, т. е. неравновесные электроны в зоне проводимости и дырки в валентной зоне, создаваемые каким-то источником накачки, обладают конечными временами жизни в зонах. На протяжении этого времени термодинамическое равновесие не соблюдается, и, следовательно, единого уровня Ферми для всей системы в целом не существует. Однако если в электронном и дырочном газах в отдельности за время, меньшее времени жизни носителей в зонах, устанавливается свое квазиравновесное состояние фермиевского типа, но с одной и той же температурой для всей системы, а равновесие между этими газами отсутствует, то можно ввести так называемые квазиуровни Ферми отдельно для электронов в зоне проводимости mn и дырок в валентной зоне mp.
Допустимость введения отдельных квазиравновесных функций распределения для дырок и электронов в валентной зоне и в зоне проводимости соответственно априорно не очевидна. Она оправдывается тем, что по крайней мере в нескольких полупроводниках время термализации электронов в пределах зоны (0.1 пс) на три – четыре порядка меньше характерного времени межзонной термализации (1–10 нс).
Вернемся к условию инверсии (10). Представив в соответствии с проведенным выше обсуждением f(E2) и f(E1) в виде
| | | | частью неона. Непосредственно в генерации участвуют лишь энергетические уровни неона; гелий необходим для создания эффективного механизма возбуждения атомов неона. Большинство He–Ne-лазеров возбуждается разрядом постоянного тока, создаваемым высоким напряжением, приложенным к заполненному газом объему. Атомы гелия легко перевести электронным ударом в одно из нескольких метастабильных энергетических состояний.
Атом неона, имеющий на внешней оболочке на шесть электронов больше, чем гелий, обладает крайне сложной схемой возбужденных состояний. Энергии двух из этих состояний почти точно совпадают со значениями энергии для двух из метастабильных состояний гелия. Если энергии настолько близки, то соударение атома гелия с неоном может приводить к эффективной передаче энергии от атома гелия в метастабильном состоянии к атому неона в основном состоянии. Столкновение, которое приводит к такому типу передачи энергии, называется резонансным соударением. Схема энергетических уровней гелия и неона показана на рис. 1.
В литературе встречаются различные обозначения энергетических уровней атомов. Часто применяется система обозначений, отвечающая LS-связи. В этом случае состояние атома характеризуется суммарным орбитальным моментом L и суммарным спиновым моментом S. Спектральные термы в зависимости от величины L обозначаются символами S, P, D, F … и т.д. Так, состояние с L = 0 обозначается символом S, состояние с L = 1 – символом P, состояние с L = 2 – символом D и т. д. Сверху слева от этих символов указывается мультиплетность терма 2S + 1, внизу справа – полный момент атома J, а перед буквой, обозначающей спектральный терм, ставится значение главного квантового числа возбужденного электрона. Например, обозначение 31P1 означает, что речь идет о терме, у которого L = 1, J = 1, 2S + 1 = 1, т. е. S = 0 и главное квантовое число n = 3.
Часто в литературе пользуются обозначениями Пашена. Они компактны и носят полуэмпирический характер, не имея | |



 1S0 и 21S0
1S0 и 21S0 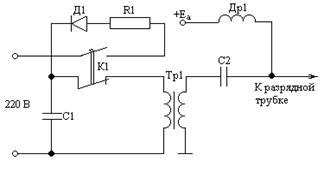
 , (2)
При равновесии
, (2)
При равновесии  , следовательно, в силу (1) имеем
, следовательно, в силу (1) имеем
 , (3)
Дальнейший анализ требует учета специфики полупроводников. Выделим в спектре электронных состояний два уровня с энергиями Е2 > Е1. Скорость излучательной рекомбинации на переходе Е2 ® Е1 пропорциональна произведению концентраций электронов на уровне Е2 и дырок на уровне Е1.
Электроны, как известно, подчиняются статистике Ферми – Дирака. Вероятность того, что электрон находится в состоянии с энергией Е, задается распределением Ферми:
, (3)
Дальнейший анализ требует учета специфики полупроводников. Выделим в спектре электронных состояний два уровня с энергиями Е2 > Е1. Скорость излучательной рекомбинации на переходе Е2 ® Е1 пропорциональна произведению концентраций электронов на уровне Е2 и дырок на уровне Е1.
Электроны, как известно, подчиняются статистике Ферми – Дирака. Вероятность того, что электрон находится в состоянии с энергией Е, задается распределением Ферми:
 , (4)
где m – энергия (уровень Ферми). Вероятность найти на уровне энергии Е дырку равна вероятности того, что этот уровень не занят электроном и составляет, следовательно,
, (4)
где m – энергия (уровень Ферми). Вероятность найти на уровне энергии Е дырку равна вероятности того, что этот уровень не занят электроном и составляет, следовательно,
 . (5)
Тогда скорость спонтанной рекомбинации, пропорциональная числу электронов на уровне Е2 и числу дырок на уровне Е1, может быть представлена в виде
. (5)
Тогда скорость спонтанной рекомбинации, пропорциональная числу электронов на уровне Е2 и числу дырок на уровне Е1, может быть представлена в виде
 , (6)
, (6)
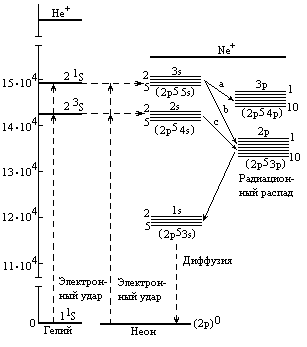 Рис.1. Схема энергетических уровней He–Ne-лазера:
а – l = 3.39 мкм,
b –l = 0.63 мкм,
c – l = 1.15 мкм
В разряде происходит возбуждение атомов Не и Ne за счет прямого электронного возбуждения. Атомы Не при столкновении с атомами Ne могут передавать энергию возбуждения с уровней 21S0 и 23S1 на уровни 3s2 и 2s2 атома Ne, что приводит к их селективному заселению.
Инверсию населенностей и затем генерацию удается получить на большом числе переходов атома Ne в диапазоне длин волн от 0.6 до 133 мкм. Наиболее известны переходы 2s2 ® 2p4 (l = 1.15 мкм, стрелка с на рис. 1), 3s2 ® 3p4 (l = 3.39 мкм, стрелка а), 3s2 ® 2p4 (l = 0.63 мкм, стрелка b).
Рассмотрим энергетическую схему гелия и неона.
Электронная конфигурация He: 1s2.
Основное состояние: 1S0.
Наинизшие возбужденные состояния: 23S1[19,815эВ] и
Рис.1. Схема энергетических уровней He–Ne-лазера:
а – l = 3.39 мкм,
b –l = 0.63 мкм,
c – l = 1.15 мкм
В разряде происходит возбуждение атомов Не и Ne за счет прямого электронного возбуждения. Атомы Не при столкновении с атомами Ne могут передавать энергию возбуждения с уровней 21S0 и 23S1 на уровни 3s2 и 2s2 атома Ne, что приводит к их селективному заселению.
Инверсию населенностей и затем генерацию удается получить на большом числе переходов атома Ne в диапазоне длин волн от 0.6 до 133 мкм. Наиболее известны переходы 2s2 ® 2p4 (l = 1.15 мкм, стрелка с на рис. 1), 3s2 ® 3p4 (l = 3.39 мкм, стрелка а), 3s2 ® 2p4 (l = 0.63 мкм, стрелка b).
Рассмотрим энергетическую схему гелия и неона.
Электронная конфигурация He: 1s2.
Основное состояние: 1S0.
Наинизшие возбужденные состояния: 23S1[19,815эВ] и , (7)
где В1 и В2 – коэффициенты пропорциональности. Подставляя эти выражения для А и В в (3) и учитывая равновесные распределения (2) и (4), получаем уравнение
, (7)
где В1 и В2 – коэффициенты пропорциональности. Подставляя эти выражения для А и В в (3) и учитывая равновесные распределения (2) и (4), получаем уравнение
 . (8)
По предположению фотоны с энергией
. (8)
По предположению фотоны с энергией  возникают в результате прямозонной излучательной рекомбинации, происходящей между уровнями Е2 и Е1; значит,
возникают в результате прямозонной излучательной рекомбинации, происходящей между уровнями Е2 и Е1; значит,  . (9)
Следовательно, разность между скоростями вынужденного испускания фотонов на переходе зона – зона при излучательной рекомбинации и поглощения фотонов на том же переходе положительна при условии
f(E2) > f(E1), (10)
если f(E) – распределение Ферми (4), представленное на рис. 2, то для пары уровней Е2 > Е1 при термодинамическом равновесии это условие не выполняется.
. (9)
Следовательно, разность между скоростями вынужденного испускания фотонов на переходе зона – зона при излучательной рекомбинации и поглощения фотонов на том же переходе положительна при условии
f(E2) > f(E1), (10)
если f(E) – распределение Ферми (4), представленное на рис. 2, то для пары уровней Е2 > Е1 при термодинамическом равновесии это условие не выполняется.
 Рис. 2. Распределение Ферми (m – уровень Ферми)
Вспомним теперь, что уровни Е2 и Е1 разделены запрещенной зоной и находятся соответственно в зоне проводимости и в валентной зоне. Неравновесные носители, т. е. неравновесные электроны в зоне проводимости и дырки в валентной зоне, создаваемые каким-то источником накачки, обладают конечными временами жизни в зонах. На протяжении этого времени термодинамическое равновесие не соблюдается, и, следовательно, единого уровня Ферми для всей системы в целом не существует. Однако если в электронном и дырочном газах в отдельности за время, меньшее времени жизни носителей в зонах, устанавливается свое квазиравновесное состояние фермиевского типа, но с одной и той же температурой для всей системы, а равновесие между этими газами отсутствует, то можно ввести так называемые квазиуровни Ферми отдельно для электронов в зоне проводимости mn и дырок в валентной зоне mp.
Допустимость введения отдельных квазиравновесных функций распределения для дырок и электронов в валентной зоне и в зоне проводимости соответственно априорно не очевидна. Она оправдывается тем, что по крайней мере в нескольких полупроводниках время термализации электронов в пределах зоны (0.1 пс) на три – четыре порядка меньше характерного времени межзонной термализации (1–10 нс).
Вернемся к условию инверсии (10). Представив в соответствии с проведенным выше обсуждением f(E2) и f(E1) в виде
Рис. 2. Распределение Ферми (m – уровень Ферми)
Вспомним теперь, что уровни Е2 и Е1 разделены запрещенной зоной и находятся соответственно в зоне проводимости и в валентной зоне. Неравновесные носители, т. е. неравновесные электроны в зоне проводимости и дырки в валентной зоне, создаваемые каким-то источником накачки, обладают конечными временами жизни в зонах. На протяжении этого времени термодинамическое равновесие не соблюдается, и, следовательно, единого уровня Ферми для всей системы в целом не существует. Однако если в электронном и дырочном газах в отдельности за время, меньшее времени жизни носителей в зонах, устанавливается свое квазиравновесное состояние фермиевского типа, но с одной и той же температурой для всей системы, а равновесие между этими газами отсутствует, то можно ввести так называемые квазиуровни Ферми отдельно для электронов в зоне проводимости mn и дырок в валентной зоне mp.
Допустимость введения отдельных квазиравновесных функций распределения для дырок и электронов в валентной зоне и в зоне проводимости соответственно априорно не очевидна. Она оправдывается тем, что по крайней мере в нескольких полупроводниках время термализации электронов в пределах зоны (0.1 пс) на три – четыре порядка меньше характерного времени межзонной термализации (1–10 нс).
Вернемся к условию инверсии (10). Представив в соответствии с проведенным выше обсуждением f(E2) и f(E1) в виде
 , (11)
где mn – квазиуровень Ферми для электронов, а mр – для дырок, из неравенства (10) легко получить эквивалентное ему, но более наглядное условие:
Fn – Fp > E2 – E1. (12)
Так как минимальное значение Е2 – Е1 равно ширине запрещенной зоны Eg, условие инверсии приобретает простой вид:
mn – mp > Eg. (13)
Следовательно, накачка, создающая неравновесность, должна быть достаточно сильной для того, чтобы квазиуровни Ферми оказались внутри соответствующих разрешенных зон энергии. Это означает, что электронный и дырочный газы вырождены, при этом все уровни в валентной зоне с энергией Е1 > mр практически полностью не заселены, а все уровни в зоне проводимости с энергией Е2 < mn практически полностью заселены электронами. Тогда фотоны, энергия которых лежит в интервале
, (11)
где mn – квазиуровень Ферми для электронов, а mр – для дырок, из неравенства (10) легко получить эквивалентное ему, но более наглядное условие:
Fn – Fp > E2 – E1. (12)
Так как минимальное значение Е2 – Е1 равно ширине запрещенной зоны Eg, условие инверсии приобретает простой вид:
mn – mp > Eg. (13)
Следовательно, накачка, создающая неравновесность, должна быть достаточно сильной для того, чтобы квазиуровни Ферми оказались внутри соответствующих разрешенных зон энергии. Это означает, что электронный и дырочный газы вырождены, при этом все уровни в валентной зоне с энергией Е1 > mр практически полностью не заселены, а все уровни в зоне проводимости с энергией Е2 < mn практически полностью заселены электронами. Тогда фотоны, энергия которых лежит в интервале
 , (14)
не могут вызвать переходы валентная зона – зона проводимости и поэтому не поглощаются. Обратные переходы зона проводимости – валентная зона возможны. Вынужденная излучательная рекомбинация на этих переходах как раз и создает лазерное излучение. Неравенства (14) определяют ширину полосы соответствующего усиления.
5. Излучение p-n-перехода
, (14)
не могут вызвать переходы валентная зона – зона проводимости и поэтому не поглощаются. Обратные переходы зона проводимости – валентная зона возможны. Вынужденная излучательная рекомбинация на этих переходах как раз и создает лазерное излучение. Неравенства (14) определяют ширину полосы соответствующего усиления.
5. Излучение p-n-перехода
 , (15)
, (15)
 , (16)
где mn и mp – квазиуровни Ферми; Eg – ширина запрещенной зоны. (Равновесное распределение поддерживается в результате взаимодействия носителей с кристаллической решеткой. Если, например, в определённый момент времени некоторые носители получат дополнительную внешнюю энергию и число носителей с большей энергией станет превышать норму, то через короткое время (10 - 11 – 10 - 13 с) статистическое распределение восстановится.) У вырожденных полупроводников квазиуровни Ферми находятся внутри зон.
Если n- и р-типы полупроводника привести в контакт, то произойдет встречная диффузия и рекомбинация электронов из n-области и дырок из p-области1 до
, (16)
где mn и mp – квазиуровни Ферми; Eg – ширина запрещенной зоны. (Равновесное распределение поддерживается в результате взаимодействия носителей с кристаллической решеткой. Если, например, в определённый момент времени некоторые носители получат дополнительную внешнюю энергию и число носителей с большей энергией станет превышать норму, то через короткое время (10 - 11 – 10 - 13 с) статистическое распределение восстановится.) У вырожденных полупроводников квазиуровни Ферми находятся внутри зон.
Если n- и р-типы полупроводника привести в контакт, то произойдет встречная диффузия и рекомбинация электронов из n-области и дырок из p-области1 до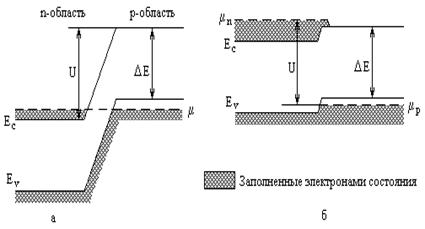 Рис. 3. Энергетическая диаграмма вырожденного p–n-перехода:
а – внешнее напряжение отсутствует;
б – внешнее напряжение приложено в прямом направлении
Если к образцу приложить внешнее напряжение в прямом направлении, т. е. напряжение, создающее поле, противоположное направлению контактного поля, то потенциальный барьер уменьшится. При достаточно большой величине приложенного внешнего напряжения энергетическая диаграмма вырожденного p–n-перехода
Рис. 3. Энергетическая диаграмма вырожденного p–n-перехода:
а – внешнее напряжение отсутствует;
б – внешнее напряжение приложено в прямом направлении
Если к образцу приложить внешнее напряжение в прямом направлении, т. е. напряжение, создающее поле, противоположное направлению контактного поля, то потенциальный барьер уменьшится. При достаточно большой величине приложенного внешнего напряжения энергетическая диаграмма вырожденного p–n-перехода Рис. 9. Построение диаграммы направленности
3. Отключить блок питания лазера.
4. а). Калибровка ИЛД-2М. На измерительном приборе переключить кнопку "изм/поиск" в положение "поиск". Нажать кнопку "калибр Дж/Вт" и, удерживая ее, потенциометром вывести стрелку прибора на красную риску. Нажать кнопку "сброс". Перевести кнопку "изм/поиск" в положение "изм".
б). Компенсация фона. Нажать кнопку "Вт" на блоке преобразования и регистрации (БПР) и на измерительной головке (ИГ). Потенциометрами для канала А "грубо" и "плавно" на ИГ вывести стрелку БПР в "0". На БПР и на ИГ нажать кнопку "Дж".
в). Диапазон длительностей измеряемого импульса на БПР и ИГ должен быть в положении "10–8...10–6 с". Предел измерений для канала А на БПР – "3 × 10–8 Дж".
г). Если требуется, нажать кнопку "сброс Дж/Вт" на БПР для того, чтобы вернуть стрелку в начало шкалы прибора.
д). Включить блок питания лазера, снять отсчет энергии при разных положениях кнопки "мгн/макс".
9. Содержание отчета
Рис. 9. Построение диаграммы направленности
3. Отключить блок питания лазера.
4. а). Калибровка ИЛД-2М. На измерительном приборе переключить кнопку "изм/поиск" в положение "поиск". Нажать кнопку "калибр Дж/Вт" и, удерживая ее, потенциометром вывести стрелку прибора на красную риску. Нажать кнопку "сброс". Перевести кнопку "изм/поиск" в положение "изм".
б). Компенсация фона. Нажать кнопку "Вт" на блоке преобразования и регистрации (БПР) и на измерительной головке (ИГ). Потенциометрами для канала А "грубо" и "плавно" на ИГ вывести стрелку БПР в "0". На БПР и на ИГ нажать кнопку "Дж".
в). Диапазон длительностей измеряемого импульса на БПР и ИГ должен быть в положении "10–8...10–6 с". Предел измерений для канала А на БПР – "3 × 10–8 Дж".
г). Если требуется, нажать кнопку "сброс Дж/Вт" на БПР для того, чтобы вернуть стрелку в начало шкалы прибора.
д). Включить блок питания лазера, снять отсчет энергии при разных положениях кнопки "мгн/макс".
9. Содержание отчета
 Рис. 8. Схема установки для определения угла расходимости лазерного излучения
2. Определить угол расходимости лазерного излучения. Для этого необходимо снять зависимость амплитуды сигнала ИЛД-2М от координаты х (характеристические кривые) при разных
положениях ИЛД-2М (0, 1, 2, 3), расстояние между которыми 5 мм. Дальнейшее же нахождение угла расходимости связано с определением тангенса угла наклона
Рис. 8. Схема установки для определения угла расходимости лазерного излучения
2. Определить угол расходимости лазерного излучения. Для этого необходимо снять зависимость амплитуды сигнала ИЛД-2М от координаты х (характеристические кривые) при разных
положениях ИЛД-2М (0, 1, 2, 3), расстояние между которыми 5 мм. Дальнейшее же нахождение угла расходимости связано с определением тангенса угла наклона Рис. 4. Спектр излучения полупроводникового лазера и светодиода, работающего на уровне ниже порогового
Процесс установления генерации в светодиоде происходит не так эффектно, как в газовом лазере. При увеличении тока в светодиоде до порогового значения резко
Рис. 4. Спектр излучения полупроводникового лазера и светодиода, работающего на уровне ниже порогового
Процесс установления генерации в светодиоде происходит не так эффектно, как в газовом лазере. При увеличении тока в светодиоде до порогового значения резко Рис. 7. Электрическая схема лазера
В данной работе изучается лазер ЛПИ-102 – полупроводниковый инжекционный многомодовый лазер импульсного режима работы.
Конструктивно лазер представляет собой герметичный металлостеклянный корпус, в котором размещены лазерный диод Д2, два динистора Э1 и Э2, два накопительных конденсатора С1 и С2 и зарядный диод Д1. Диод на основе GaAs2 (Д2) служит источником оптического излучения при прохождении через него импульсного тока определенной амплитуды. Динисторы Э1 и Э2 на основе GaAs выполняют роль ключа, переходя под действием запускающего импульса из закрытого состояния с большим сопротивлением в открытое состояние с малым сопротивлением.
Электрическая принципиальная схема лазера представлена на рис. 7. При подаче напряжения питания и запускающего импульса на лазер разрядный ток конденсаторов С1 и С2, проходя через лазерный диод Д2, вызывает оптическое излучение.
Основные характеристики лазера:
длина волны генерации – г = (800 - 950) нм,
ширина линии генерации – не более 10 нм.
Рис. 7. Электрическая схема лазера
В данной работе изучается лазер ЛПИ-102 – полупроводниковый инжекционный многомодовый лазер импульсного режима работы.
Конструктивно лазер представляет собой герметичный металлостеклянный корпус, в котором размещены лазерный диод Д2, два динистора Э1 и Э2, два накопительных конденсатора С1 и С2 и зарядный диод Д1. Диод на основе GaAs2 (Д2) служит источником оптического излучения при прохождении через него импульсного тока определенной амплитуды. Динисторы Э1 и Э2 на основе GaAs выполняют роль ключа, переходя под действием запускающего импульса из закрытого состояния с большим сопротивлением в открытое состояние с малым сопротивлением.
Электрическая принципиальная схема лазера представлена на рис. 7. При подаче напряжения питания и запускающего импульса на лазер разрядный ток конденсаторов С1 и С2, проходя через лазерный диод Д2, вызывает оптическое излучение.
Основные характеристики лазера:
длина волны генерации – г = (800 - 950) нм,
ширина линии генерации – не более 10 нм.
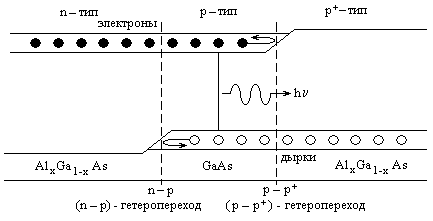 Рис. 6. Схема энергетических зон лазера с двойным гетеропереходом.
n–p–гетеропереход слева создает барьер, препятствующий перемещению дырок в n–область. р–р+–гетеропереход справа препятствует инжекции электронов в р+–область. Оба перехода, тем не менее, позволяют легко проходить другим носителям заряда в область перехода.
В р–р+-гетеропереходе увеличение ширины запрещенной зоны в AlxGa1–xAs по сравнению с шириной запрещенной зоны в GaAs создает потенциальный барьер, который отражает инжектируемые электроны; n–p-гетеропереход мешает дыркам переходить в область n–типа, что в свою очередь, не позволяет электронам инжектироваться в область перехода. Эта структура делает эффективную ширину перехода больше и ограничивает рекомбинационное излучение областью перехода. Пороговая плотность тока в двусторонних гетероструктурах уменьшается приблизительно до 2000 А/см2, в то время как в односторонних гетероструктурах она равна 8000 А/см2, а в гомолазерах 40000 А/см2.
Благодаря строгому ограничению зоны излучения только активной областью, с уменьшением пороговой плотности тока связано увеличение эффективности мощности. Некоторые выпускаемые промышленностью лазеры на гетероструктурах работают в непрерывном режиме при комнатной температуре и могут иметь мощность излучения 5 мВт на длине волны 820 нм при пороговом токе
Рис. 6. Схема энергетических зон лазера с двойным гетеропереходом.
n–p–гетеропереход слева создает барьер, препятствующий перемещению дырок в n–область. р–р+–гетеропереход справа препятствует инжекции электронов в р+–область. Оба перехода, тем не менее, позволяют легко проходить другим носителям заряда в область перехода.
В р–р+-гетеропереходе увеличение ширины запрещенной зоны в AlxGa1–xAs по сравнению с шириной запрещенной зоны в GaAs создает потенциальный барьер, который отражает инжектируемые электроны; n–p-гетеропереход мешает дыркам переходить в область n–типа, что в свою очередь, не позволяет электронам инжектироваться в область перехода. Эта структура делает эффективную ширину перехода больше и ограничивает рекомбинационное излучение областью перехода. Пороговая плотность тока в двусторонних гетероструктурах уменьшается приблизительно до 2000 А/см2, в то время как в односторонних гетероструктурах она равна 8000 А/см2, а в гомолазерах 40000 А/см2.
Благодаря строгому ограничению зоны излучения только активной областью, с уменьшением пороговой плотности тока связано увеличение эффективности мощности. Некоторые выпускаемые промышленностью лазеры на гетероструктурах работают в непрерывном режиме при комнатной температуре и могут иметь мощность излучения 5 мВт на длине волны 820 нм при пороговом токе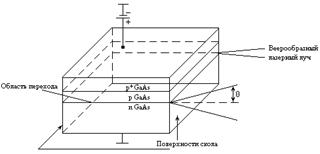 Рис. 5. Устройство полупроводникового лазера.
Лазеры изготавливают, наращивая полупроводниковую пленку n–типа на подложку p+-типа, или наоборот – пленку р+ на подложку n-типа (p+ означает сильнолегированный полупроводник р-типа, который обеспечивает хороший омический контакт). Во время наращивания или после него необходима термическая обработка для того, чтобы некоторая доля примеси р-типа диффундировала в область n-типа и образовалась слаболегированная р-область. В результате получается структура р+–р–n-типа. Электроны инжектируются из n- в р- область, где они рекомбинируют с дырками и излучают свет.
Полупроводниковые лазеры, изготовленные из полупроводника одного сорта, например GaAs, называются гомолазерами. Гомолазеры имеют некоторые недостатки по сравнению с гетеролазерами, которые изготавливают из различных веществ. И в тех, и в других лазерах для эффективного возбуждения стимулированного излучения инжекция электронов и излучение света должны ограничиваться областью перехода. В гомолазерах ограничение излучения областью перехода является следствием наличия в ней свободных электронов и дырок. Они увеличивают показатель преломления, в результате чего генерируемое излучение испытывает полное внутренне отражение и не выходит из области перехода. Хотя такой механизм удержания излучения работает достаточно хорошо и обеспечивает возможность генерации в гомолазере, для
Рис. 5. Устройство полупроводникового лазера.
Лазеры изготавливают, наращивая полупроводниковую пленку n–типа на подложку p+-типа, или наоборот – пленку р+ на подложку n-типа (p+ означает сильнолегированный полупроводник р-типа, который обеспечивает хороший омический контакт). Во время наращивания или после него необходима термическая обработка для того, чтобы некоторая доля примеси р-типа диффундировала в область n-типа и образовалась слаболегированная р-область. В результате получается структура р+–р–n-типа. Электроны инжектируются из n- в р- область, где они рекомбинируют с дырками и излучают свет.
Полупроводниковые лазеры, изготовленные из полупроводника одного сорта, например GaAs, называются гомолазерами. Гомолазеры имеют некоторые недостатки по сравнению с гетеролазерами, которые изготавливают из различных веществ. И в тех, и в других лазерах для эффективного возбуждения стимулированного излучения инжекция электронов и излучение света должны ограничиваться областью перехода. В гомолазерах ограничение излучения областью перехода является следствием наличия в ней свободных электронов и дырок. Они увеличивают показатель преломления, в результате чего генерируемое излучение испытывает полное внутренне отражение и не выходит из области перехода. Хотя такой механизм удержания излучения работает достаточно хорошо и обеспечивает возможность генерации в гомолазере, для