
Полезное:
Как сделать разговор полезным и приятным
Как сделать объемную звезду своими руками
Как сделать то, что делать не хочется?
Как сделать погремушку
Как сделать так чтобы женщины сами знакомились с вами
Как сделать идею коммерческой
Как сделать хорошую растяжку ног?
Как сделать наш разум здоровым?
Как сделать, чтобы люди обманывали меньше
Вопрос 4. Как сделать так, чтобы вас уважали и ценили?
Как сделать лучше себе и другим людям
Как сделать свидание интересным?

Категории:
АрхитектураАстрономияБиологияГеографияГеологияИнформатикаИскусствоИсторияКулинарияКультураМаркетингМатематикаМедицинаМенеджментОхрана трудаПравоПроизводствоПсихологияРелигияСоциологияСпортТехникаФизикаФилософияХимияЭкологияЭкономикаЭлектроника

Технология изготовления и классификация биполярных транзисторов
|
|
Промышленность выпускает большое количество различных БТ, отличающихся своими параметрами, конструктивным исполнением, используемыми материалами, технологией изготовления и др. Например, диапазон мощности усиленных сигналов для различных транзисторов простирается от десятков милливатт до сотен ватт, диапазон частот усиливаемых сигналов – от сотен килогерц до десятков гигагерц и т.д.
В пределах диапазонов основных физических параметров все транзисторы подразделяются на ряд групп: по диапазону частот на низкочастотные (НЧ) – до 30 Мгц, высокочастотные (ВЧ) – до300 МГц, сверхвысокочастотные (СВЧ) - свыше 300 МГц.
По мощности БТ подразделяются на маломощные – до 0,3 Вт, средней мощности – до 1,5 Вт, мощные транзисторы – свыше 1,5 Вт.
Параметры транзисторов целиком и полностью определяются технологией их изготовления и используемыми материалами.
До 1960 г. выпускались, в основном, сплавные германиевые транзисторы,. Сплавные p-n переходы образовывались в результате вплавления в исходный кристалл полупроводника донорных и акцепторных легирующих примесей. Из-за неупорядоченности границ их вплавления толщина базы W таких транзисторов составляла более 30 мкм, а также возникали дефекты кристаллической решётки и краевые эффекты. В результате запрещённая зона заселялась нежелательными примесными состояниями. Кроме того, эта технология не позволяла получать большие площади переходов, а значит, большие значения токов транзисторов. В итоге, сплавные БТ имели коэффициенты усиления тока не более 60-ти, их частотный диапазон не превышал нескольких мегагерц, а предельные значения токов транзистора – нескольких десятков ампер.
Современные транзисторы изготавливаются, по большей части, из кремния по эпитаксиально-планарной технологии - ЭПТ (эпитаксия (от греч. эпи — на, таксис — упорядоченность, планарная от англ. plane - плоскость). ЭПТ - это закономерно ориентированное наращивание кристаллов одного вещества на поверхность другого в виде тонких плёнок. Хороший контакт плёнки одного вещества с поверхностью другого достигается, если близки по величине основные параметры кристаллических решёток веществ, из которых наиболее важным является постоянная решётки a – расстояние между ядрами атомов. Явление эпитаксии широко используется в современной микроэлектронике при выращивании тонких монокристаллических полупроводниковых пленок. Путем последовательного наращивания эпитаксиальных пленок образуются так называемые сандвич-структуры, на основе которых создаются транзисторы, интегральные микросхемы и т.п. На рис.Т2а изображён поперечный разрез фрагмента подложки (о подложке см. ниже), на котором сформирован с помощью ЭПТ биполярный транзистор, на рис.Т2б приведен вид этого фрагмента сверху (в плане), на котором указаны границы эмиттерной и базовой областей с указанием геометрических размеров эмиттера – длины аЭ и ширины бЭ, а также конфигурация их контактных площадок. На рис. Т2в приведены распределения концентраций примесей по координате x (см. рис.Т2а) в направлении от эмиттера к подложке для сечения, проходящего через эмиттерную область (x =0 на эмиттерном контакте). Здесь  концентрации доноров в эмиттере, коллекторе, подложке соответственно;
концентрации доноров в эмиттере, коллекторе, подложке соответственно;  – концентрация акцепторов в базе.
– концентрация акцепторов в базе.
Рассмотрим процесс создания n-p-n транзистора с использованием ЭПТ.
Исходный материал получают в процессе плавления шихты, в которой помимо самого полупроводника, например, кремния, содержатся легирующие примеси, определяющие тип проводимости примесного полупроводника. Далее из расплава вытягивают по методу Чохральского слитки цилиндрической формы диаметром около 100 мм, которые затем распиливают на тонкие – толщиной один миллиметр – пластины, называемые подложками. Подложка является несущей конструкцией, на которой создаются структуры транзисторов. Содержание легирующей донорной примеси в подложке  порядка 1018–1019 см-3 и приближается к пределу растворимости примеси в собственном кремнии, т.е. примерно один атом примеси на 100 – 1000 атомов собственного кремния. Как следствие, материал подложки имеет высокую электропроводность, являясь низкоомным материалом. Тип проводимости таких сильно легированных материалов в зависимости от типа примеси обозначается как n+ или p+.
порядка 1018–1019 см-3 и приближается к пределу растворимости примеси в собственном кремнии, т.е. примерно один атом примеси на 100 – 1000 атомов собственного кремния. Как следствие, материал подложки имеет высокую электропроводность, являясь низкоомным материалом. Тип проводимости таких сильно легированных материалов в зависимости от типа примеси обозначается как n+ или p+.
Далее подложка шлифуется, полируется, подвергается тонким методам очистки и обезжиривания, что позволяет получить поверхность с минимальным количеством дефектов. Подготовка подложек не связана с изготовлением каких либо конкретных приборов или устройств и является общей стартовой операцией. На подложке, как правило, формируется много однотипных структур - транзисторов, микросхем или иных устройств.
После подготовки подложки на её поверхности выращивается эпитаксиальный слой кремния n -типа проводимости толщиной несколько
| Рис.Т2.Структура планарного транзистора |
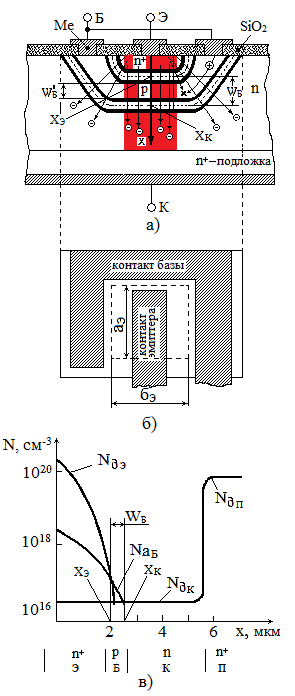 микрометров. В этом слое и создаётся структура будущего транзистора. Одновременно этот слой является коллектором транзистора. Содержание в нём примеси N ДК существенно меньше, чем в подложке.
микрометров. В этом слое и создаётся структура будущего транзистора. Одновременно этот слой является коллектором транзистора. Содержание в нём примеси N ДК существенно меньше, чем в подложке.
На полученную эпитаксиальную структуру наносят тонкий защитный (маскирующий) слой диоксида кремния SiO2 (либо нитрида кремния Si3N4) путем термического окисления кремния в среде кислорода при температуре 50 – 1200 оС. Оксид кремния является диэлектриком, он гидрофобен, что очень важно, и хорошо растворяется в плавиковой кислоте.
Последующие операции проводятся с использованием метода фотолитографии. На окисленную пластину кремния наносят фоторезист – вещество, изменяющее свои прочностные свойства под действием электромагнитного излучения оптического диапазона (света). На слой фоторезиста накладывают маску, представляющую собой светонепроницаемую плёнку (фотошаблон), перфорированную отверстиями, задающими конфигурацию элементов структур создаваемых приборов. Слой фоторезиста экспонируют (засвечивают) через фотошаблон, после чего засвеченные участки фоторезиста «проявляют», т.е. удаляют в растворителе. Затем в растворе, содержащем плавиковую кислоту, травят обнажившуюся в фоторезисте плёнку диоксида кремния (на фоторезист кислота не действует), вскрывая в ней «окна» Оставшийся фоторезист полностью удаляют, после чего проводят диффузию акцепторной примеси в образовавшиеся окна на глубину хк, формируя p -область. В результате образуется коллекторный p - n переход, обеднённая область которого ограничена двумя жирными линиями, а металлургическая граница между p - и n -областями обозначена линией пунктирной (рис.Т2а). После этого поверхность пластины покрывают плёнкой диоксида кремния и вновь проводят фотолитографию, позволяющую вскрыть окна (несколько меньшие по размерам, чем в предыдущем случае) под диффузию донорной примеси на глубину х э. В результате образуется низкоомная n + - область эмиттера с концентрацией примеси ещё более высокой, чем у подложки, и образуется эмиттерный переход, также показанный двумя жирными линиями и пунктирной линией металлургической границы между областями эмиттера и базы. Металлургические границы эмиттерного хэ и коллекторного хк переходов (рис.Т2а и Т2в) проходят по точкам, в которых N ДЭ(x Э)= N АБ(x Э) и N АБ(х К)= N ДК(х К). Здесь N ДЭ, N ДК – концентрации доноров в области эмиттера и коллектора соответственно, N АБ - концентрация акцепторов в области базы; х К, х Э – глубина диффузии примеси, формирующей область коллектора и эмиттера соответственно. Технологическая ширина базы W Б= хК-хЭ, и для маломощных и высокочастотных БТ не превышает 0,15мкм. Физическая ширина базы  равна расстоянию между границами обеднённых слоёв эмиттерного и коллекторного переходов и потому меньше технологической ширины.
равна расстоянию между границами обеднённых слоёв эмиттерного и коллекторного переходов и потому меньше технологической ширины.
Следующей операцией является создание контактных площадок и межсоединений. Хороший омический контакт должен иметь сопротивление близкое к нулю и симметричную линейную ВАХ в соответствии с законом Ома. Если наносить металлизацию непосредственно на n-область эмиттера, то получается барьер Шоттки, обладающий вентильными (выпрямительными) свойствами. В случае же сильного легирования, при котором получают n + -тип проводимости, толщина области пространственного заряда (обеднённой области) барьера на границе «металл- n +- полупроводник»становится настолько малой, что через него возможно туннелирование носителей заряда, что позволяет получить требуемые характеристики контакта. Именно поэтому подложку и область эмиттера сильно легируют.
Для создания планарных омических контактов и межсоединений на верхней поверхности структуры пластина вновь окисляется и проводится фотолитография, позволяющая вскрыть окна под омические контакты базы и эмиттера. Затем на верхней поверхности пластины осуществляется металлизация путём нанесения на поверхность пластины сплошной металлической плёнки, например, алюминия методами термического испарения или катодного распыления. По металлизации проводится фотолитография, в ходе которой убирается лишний металл и остаются контактные площадки базы и эмиттера (косая штриховка на рис.Т2а, Т2б, Ме –означает металл на рис.Т2а).
На заключительной стадии пластина разрезается на отдельные кристаллы, к контактным площадкам ультразвуковой сваркой привариваются тоководы, после чего кристалл помещают в корпус, снабжают внешними выводами, герметизируют, окрашивают и маркируют. Существуют также бескорпусные транзисторы, предназначенные для создания различных микросборок. Защита от внешней среды таких транзисторов достигается нанесением на кристалл полимерного покрытия.
Если необходимо создать интегральную микросхему, то транзисторы, сформированные на подложке, соединяют согласно принципиальной схеме, при этом в качестве резисторов используют базы транзисторов, у которых сравнительно высокие сопротивления вследствие низкого уровня их легирования, в качестве диодов – эмиттерный и коллекторный переходы, в качестве ёмкостей – барьерные или диффузионные ёмкости p-n переходов.
Если имеет место прямое смещение эмиттерного перехода и происходит, как следствие, процесс диффузии электронов (обозначены как  ) из эмиттера в базу, то, как следует из рис.Т2а, в каком бы направлении ни двигались электроны – они попадают в поле коллекторного перехода, чья площадь существенно больше площади эмиттерного перехода. Инжектированные в базу электроны движутся не только в вертикальном, но и в боковых направлениях. Однако, поскольку в вертикальном направлении толщина базы существенно меньше, чем в горизонтальном направлении, то краевыми эффектами можно пренебречь и учитывать движение электронов в области базы, непосредственно расположенной под эмиттером. Данную часть базы называют активной, а остальную часть базы, с которой непосредственно соединены контактные площадки – пассивной. Отсюда следует, что p-n переходы в первом приближении можно считать плоскими, и для анализа процессов, происходящих в БТ, рассматривать одномерную модель его структуры (выделена цветом на рис. Т2а). Влияние пассивной базы можно учесть, вводя в схему замещения БТ резистор, чьё сопротивление равно объёмному сопротивлению пассивной области базы.
) из эмиттера в базу, то, как следует из рис.Т2а, в каком бы направлении ни двигались электроны – они попадают в поле коллекторного перехода, чья площадь существенно больше площади эмиттерного перехода. Инжектированные в базу электроны движутся не только в вертикальном, но и в боковых направлениях. Однако, поскольку в вертикальном направлении толщина базы существенно меньше, чем в горизонтальном направлении, то краевыми эффектами можно пренебречь и учитывать движение электронов в области базы, непосредственно расположенной под эмиттером. Данную часть базы называют активной, а остальную часть базы, с которой непосредственно соединены контактные площадки – пассивной. Отсюда следует, что p-n переходы в первом приближении можно считать плоскими, и для анализа процессов, происходящих в БТ, рассматривать одномерную модель его структуры (выделена цветом на рис. Т2а). Влияние пассивной базы можно учесть, вводя в схему замещения БТ резистор, чьё сопротивление равно объёмному сопротивлению пассивной области базы.
Одномерные структуры кристаллов транзисторов и условные их обозначения на схемах приведены на рис. Т3. Кружками обозначены внешние выводы транзистора, с помощью которых он соединяется (как правило, посредством пайки) с остальными компонентами усилительного устройства. Пунктирными линиями указаны металлургические границы между примесными областями, косой штриховкой обозначены границы эмиттерного (1) и коллекторного (2) переходов.
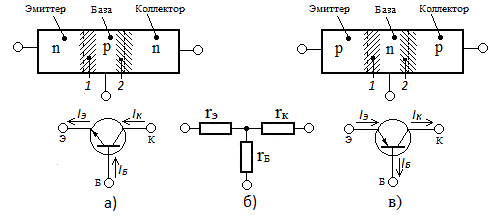
Рис.Т3. Структуры кристаллов, схема замещения и условные обозначения p-n-p и n-p-n биполярных транзисторов
Поскольку, как отмечалось ранее, концентрация примеси в области эмиттера много больше, чем в области базы, поэтому эмиттерный переход несимметричен и, в основном, сосредоточен в низколегированной области базы (рис.Т2в) (см. также рис.4). Физическая область базы формируется предельно тонкой, её толщина должна быть много меньше диффузионной длины, с тем, чтобы носители, попавшие в базу и диффундирующие в ней, не успевали рекомбинировать (диффузионная длина – это расстояние, на котором концентрация диффундирующих носителей уменьшается в е раз вследствие процессов рекомбинации).
Приложение напряжения к p-n переходу вызывает протекание по нему тока, это даёт основание в схемах замещения представлять переход в виде резистора. Однако, поскольку связь между током перехода и приложенным к нему напряжением нелинейная, то сопротивление такого резистора должно быть дифференциальным и находится через приращения токов и напряжений относительного некоторого постоянного их значения. Что касается области базы, то она должна быть представлена резистором с постоянным сопротивлением, поскольку речь идёт об объёме полупроводника между коллекторным и эмиттерным переходами. Резистивная схема замещения БТ представлена на рис.Т3б, где rэ, rк, rб – дифференциальные сопротивления эмиттерного, коллекторного переходов и объёмное сопротивление области базы соответственно.
На рис.Т3 также указаны направления токов, проходящих по выводам БТ, а именно, тока коллектора IК, тока эмиттера IЭ и тока базы IБ для активного режима, который будет рассмотрен далее.
Date: 2015-05-09; view: 3749; Нарушение авторских прав