
Полезное:
Как сделать разговор полезным и приятным
Как сделать объемную звезду своими руками
Как сделать то, что делать не хочется?
Как сделать погремушку
Как сделать так чтобы женщины сами знакомились с вами
Как сделать идею коммерческой
Как сделать хорошую растяжку ног?
Как сделать наш разум здоровым?
Как сделать, чтобы люди обманывали меньше
Вопрос 4. Как сделать так, чтобы вас уважали и ценили?
Как сделать лучше себе и другим людям
Как сделать свидание интересным?

Категории:
АрхитектураАстрономияБиологияГеографияГеологияИнформатикаИскусствоИсторияКулинарияКультураМаркетингМатематикаМедицинаМенеджментОхрана трудаПравоПроизводствоПсихологияРелигияСоциологияСпортТехникаФизикаФилософияХимияЭкологияЭкономикаЭлектроника

Мощные МДП-транзисторы
|
|
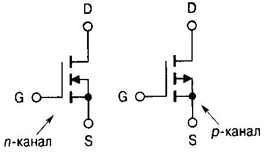 Рис. 1.10
Рис. 1.10
|
Совершенствование диффузионно-планарной технологии позволили получить многоканальные структуры мощных МДП-транзисторов (рис. 1.10). Активная область канала данных приборов формируется аналогично базе биполярного транзистора. Благодаря хорошей управляемости диффузионного процесса оказалось возможным изготовление рабочих каналов длиной менее 1 мкм с хорошей воспроизводимостью.
Для транзисторов с относительно высокими пробивными напряжениями (более 100...300 В) используют DМДП- и VМДП-структуры.
V-образный МДП-транзистор изготавливается в виде вертикальной структуры, сходной со структурой биполярного транзистора (рис. 1.8).
DМДП-мощные транзисторы с коротким каналом имеют как вертикальную, так и горизонтальную структуру базовой ячейки. Все высоковольтные DМДП-транзисторы изготавливаются только с вертикальной структурой. Исходным материалом опять же является высоколегированная подложка n+-типа (для n-канальных транзисторов). При одинаковой технологии изготовления DМДП- и VМДП-транзисторов первые, как правило, имеют более высокое пробивное напряжение, а вторые более низкое сопротивление канала в открытом состоянии. Современные транзисторы выполняется с кремниевым затвором (поликремниевым или поликристаллическим). Металлический затвор обладает значительно меньшим сопротивлением, что делает его предпочтительным в высокочастотных транзисторах.
Для низковольтных мощных МДП-транзисторов используют как уже упоминавшуюся горизонтальную DМДП-структуру, так и более совершенную UМДП-структуру. В данной ячейке затвор помещается в "канавку" (английский термин - trench). Это позволяет в несколько раз увеличить плотность размещения каналов и резко снизить остаточное сопротивление за счет еще большего уменьшения толщины эпитаксиального слоя (по сравнению с VМДП-структурой) и исключения паразитного промежутка между р-областями (по сравнению с DМДП-структурой).
Современные МДП-транзисторы с пробивным напряжением более 250,В имеют в структуре ячеек охранные кольца и полевые электроды, изменяющие форму поля и устраняющие опасные эффекты исправления и стягивания силовых линий, оказывающие сильное влияние на пробивное напряжение структуры.
Мощные МДП-транзисторы имеют структуры с индуцированным каналом, в которых для перехода прибора в открытое состояние необходимо осуществить инверсию проводимости канала, расположенного непосредственно под управляющим затвором. Это обеспечивается подачей соответствующего смещения на затвор. Для n-канального транзистора напряжение смещения является положительным, а для р-канального соответственно отрицательным. Открытое состояние ключа характеризуется прямым падением напряжения между стоком и истоком, которое в свою очередь зависит от сопротивления открытого канала.
Для высоковольтных МДП-транзисторов наибольший вклад (~95%) вносит сопротивление эпитаксиального слоя. Для низковольтных приборов сопротивление канала равномерно распределено. В высоковольтных МДП-структурах необходимо компромиссное решение между желанием повысить пробивное напряжение и снизить прямые потери. Пробивное напряжение повышается с увеличением размеров (длины) эпитаксиального n─-слоя. В то же время сопротивление Rерi возрастает пропорционально напряжению пробоя в степени 2.5...2.7. С расширением n─-слоя увеличивается также время пролета носителей от истока к стоку, что следует учитывать в транзисторах высокочастотного применения. Данные ограничения не позволяют высоковольтным МДП-структурам иметь преимущества по остаточным напряжениям перед биполярными транзисторами при заданном уровне прямого тока. Омический характер сопротивления открытого канала приводит к положительному температурному коэффициенту прямого падения напряжения. Это свойство способствует более равномерному
распределению плотности протекающего через структуру тока и повышает ее теплоустойчивость. Однако в высоковольтных структурах с высоким удельным сопротивлением следует очень осторожно относиться к повышению температуры. При постоянном токе увеличение омического сопротивления с ростом температуры приводит к еще большему рассеиванию мощности, а значит, к новому повышению температуры структуры и т.д. Если процесс становится неконтролируемым, возникает явление теплового пробоя, очень похожее на эффект вторичного пробоя в биполярном транзисторе. Для уменьшения удельного сопротивления канала в высоковольтных структурах увеличивают число параллельных базовых ячеек. Однако это увеличивает размеры кристалла и повышает его стоимость.
Принципиально новым решением проблемы уменьшения остаточного сопротивления является изменение структуры базовой ячейки. В первой главе был представлен элемент так называемой CoolMOS-технологии, в котором с помощью специального эпитаксиального процесса сформирована р-область структуры особой геометрии. Данная область имеет значительное углубление в части структуры, расположенной под затвором. При этом сопротивление открытого затвора резко снижается, так как на пути протекания тока присутствует лишь незначительная часть эпитаксиального слоя. Все базовые ячейки мощного МДП-транзистора содержат внутренний "паразитный" биполярный n-p-n-транзистор, образованный n+-истоком (эмиттер), р-областью инверсного канала (база) и эпитаксиальным n─-слоем (коллектор). Этот транзистор фактически параллельно подключен к рабочему каналу МДП-структуры (рис. 1.11). Чтобы сохранить все положительные свойства полевого транзистора, подключают части р-области к металлизированному контакту истока. Со схемотехнической точки зрения это эквивалентно закорачиванию эмиттерного перехода паразитного n-p-n-транзистора.
При высокой скорости изменения напряжения в цепи стока (эффект dv/dt) необходимо применять дополнительные защитные меры.
Подключение р-области транзистора к металлизации n+-истока создает внутри структуры еще один дополнительный элемент — обратносмещенный р-n─-переход, подобный встречно-параллельному диоду между стоком и истоком (рис. 1.11). Структурные ячейки проектируют так, чтобы данный диод по своим предельным параметрам соответствовал аналогичным показателям МДП- транзистора и имел достаточно малое время восстановления запирающих свойств.
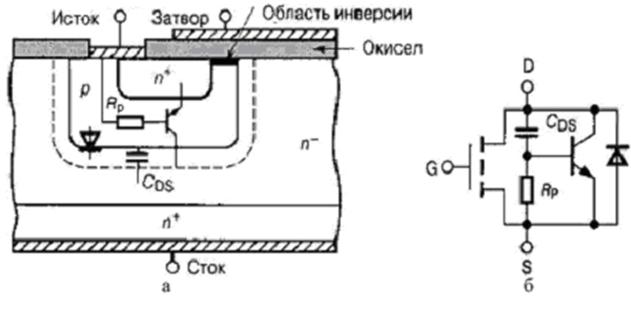
Рис. 1.11
Динамические свойства рассматриваемых ячеек определяются внутренними емкостями, среди которых различают емкости затвор-исток CGS, затвор-сток CGD и сток-исток CDS. Емкость затвор-исток состоит из двух составляющих: полевой емкости между металлизированными дорожками истока и затвора и дополнительной емкости, создаваемой перекрытием истоковой n+-области металлизированной частью затвора. Емкость затвор-сток это емкость между металлизированной частью затвора и эпитаксиальной n─-областью (рис. 1.12). Емкость сток-исток определяется барьерной емкостью стокового р-n─-перехода. Поскольку емкости CGO и CDS связаны с обедненной областью слоя, они становятся зависимыми от изменения напряжения сток-исток, уменьшаясь с его ростом (примерно в зависимости ~ (Vds)-0.5) (рис. 1.13).
 Один из главных параметров биполярного транзистора, характеризующий качество ключа - коэффициент передачи тока. Аналогом данного коэффициента в МДП-транзисторе является силовая крутизна, т.е. параметр, определяющий амплитуду выходного ток при заданном управляющем воздействии.
Один из главных параметров биполярного транзистора, характеризующий качество ключа - коэффициент передачи тока. Аналогом данного коэффициента в МДП-транзисторе является силовая крутизна, т.е. параметр, определяющий амплитуду выходного ток при заданном управляющем воздействии.
Качество МДП-структуры тем выше, чем выше крутизна и меньше паразитная емкость. С точки зрения геометрии ячейки крутизна пропорциональна ширине канала рабочего тока и обратно пропорциональна его длине, а также толщине окисла, отделяющего управляющий затвор от полупроводниковой структуры. Уменьшение толщины окисла нежелательно ввиду снижения порогового напряжения отпирания структуры ухудшения его защитных свойств от пробоя. Увеличение ширины канала приводит к росту паразитных емкостей. Единственный путь — это уменьшение длины канала за счет равномерного распределения тока основных носителей между множеством параллельных ячеек структуры. Однородность их свойств позволяют использовать некоторое количество данных ячеек для измерения тока пропорционального полному току стока. Такие приборы получили название SENSE МДП-транзисторы, которые наряду с основными выводами имеют два дополнительных, с которых может быть считана информация о силовом токе (рис. 1.114).
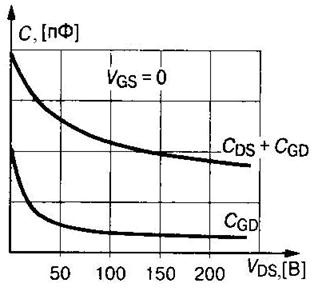

Рис. 1. 13 Рис. 1.14
Date: 2015-05-09; view: 3214; Нарушение авторских прав