
Полезное:
Как сделать разговор полезным и приятным
Как сделать объемную звезду своими руками
Как сделать то, что делать не хочется?
Как сделать погремушку
Как сделать так чтобы женщины сами знакомились с вами
Как сделать идею коммерческой
Как сделать хорошую растяжку ног?
Как сделать наш разум здоровым?
Как сделать, чтобы люди обманывали меньше
Вопрос 4. Как сделать так, чтобы вас уважали и ценили?
Как сделать лучше себе и другим людям
Как сделать свидание интересным?

Категории:
АрхитектураАстрономияБиологияГеографияГеологияИнформатикаИскусствоИсторияКулинарияКультураМаркетингМатематикаМедицинаМенеджментОхрана трудаПравоПроизводствоПсихологияРелигияСоциологияСпортТехникаФизикаФилософияХимияЭкологияЭкономикаЭлектроника

Основные теоретические положения. Основным элементом полупроводниковых приборов является p-n переход – тонкий слой на границе раздела двух полупроводников различного типа проводимости
Основным элементом полупроводниковых приборов является p-n переход – тонкий слой на границе раздела двух полупроводников различного типа проводимости.
Полупроводником n -типа называется такой полупроводник, в котором концентрация свободных электронов преобладает над концентрацией дырок. Электроны в этом случае являются основными носителями заряда, а дырки – неосновными. Преобладание концентрации электронов nn над концентрацией дырок pn достигается введением в чистый полупроводник примесных атомов, валентность которых на единицу больше, чем валентность атомов кристаллической решетки. Например, при введении в кристалл германия или кремния примесных пятивалентных атомов мышьяка (сурьмы, фосфора и т.д.) атомы примеси замещают в узлах кристаллической решетки атомы основного элемента, но один электрон не участвует в образовании ковалентной связи. Этот электрон связан с атомом слабо и при незначительном тепловом воздействии становится свободным. Такой процесс называется ионизацией примеси. При ионизации дырки не возникают, а примесные атомы, называемые в этом случае донорами, заряжаются положительно.

 С энергетической точки зрения введение в полупроводник донорных примесей связано с появлением внутри запрещенной зоны разрешенных энергетических уровней, на которых располагаются слабо связанные электроны примеси (рис. 4.1). Число таких уровней равно числу примесных атомов. Энергия ионизации донорных атомов составляет от 0,01 до 0,05 эВ, поэтому при весьма незначительном нагреве полупроводника все примесные атомы оказываются ионизированными.
С энергетической точки зрения введение в полупроводник донорных примесей связано с появлением внутри запрещенной зоны разрешенных энергетических уровней, на которых располагаются слабо связанные электроны примеси (рис. 4.1). Число таких уровней равно числу примесных атомов. Энергия ионизации донорных атомов составляет от 0,01 до 0,05 эВ, поэтому при весьма незначительном нагреве полупроводника все примесные атомы оказываются ионизированными.
В полупроводнике р -типа концентрация дырок рр преобладает над концентрацией электронов np. Это достигается введением в полупроводник примесных атомов с валентностью на единицу меньшей, чем основные атомы кристалла. При этом для одной из ковалентных связей электрона не хватает. Недостающий электрон акцептор легко захватывает у других атомов решетки. Для этого достаточно незначительно нагреть полупроводник. Процесс захвата электрона акцептором называется ионизацией акцептора. При ионизации акцептор заряжается отрицательно, а на том месте, где ранее находился электрон, образуется дырка, при этом свободный электрон не возникает. Дырки в этом случае будут основными носителями заряда, а электроны – неосновными.
С энергетической точки зрения при введении акцепторных примесей в запрещенной зоне появляются дозволенные уровни, располагаемые вблизи валентной зоны. Число этих уровней равно числу примесных атомов. При температуре абсолютного нуля уровни эти свободны. При незначительном нагреве полупроводника электроны из валентной зоны переходят на акцепторные уровни, что ведет к образованию в валентной зоне свободных энергетических уровней (дырок).
Электронно-дырочный переход
при отсутствии внешнего напряжения
 Рассмотрим явления, возникающие при контакте между полупроводниками n - и р -типа с одинаковой концентрацией донорных и акцепторных примесей. Будем считать, что на границе раздела (сечение x = 0 на рис. 4.2, а) тип примесей резко изменяется (рис. 4.2, б, где ND – концентрация доноров, NA – концентрация акцепторов). При осуществлении контакта электроны и дырки, находясь в состоянии хаотического теплового движения, начинают переходить через границу раздела x0 = 0.
Рассмотрим явления, возникающие при контакте между полупроводниками n - и р -типа с одинаковой концентрацией донорных и акцепторных примесей. Будем считать, что на границе раздела (сечение x = 0 на рис. 4.2, а) тип примесей резко изменяется (рис. 4.2, б, где ND – концентрация доноров, NA – концентрация акцепторов). При осуществлении контакта электроны и дырки, находясь в состоянии хаотического теплового движения, начинают переходить через границу раздела x0 = 0.
Поток электронов из n -области в р -область (поток 1 на рис. 4.2, а) и поток дырок из р -области в n -область (поток 2) называются потоками основных носителей заряда, а встречные потоки (потоки 3 и 4) – потоками неосновных носителей. Поскольку концентрация электронов в n -области преобладает над концентрацией электронов в р -области, то поток 1 преобладает над потоком 3, а поток 2 – над потоком 4. Преобладание потоков основных носителей над потоком неосновных носителей заряда не приводит, однако, к выравниванию концентрации носителей в обеих областях полупроводника. Это объясняется тем, что перемещение заряженных частиц сопровождается нарушением электрической нейтральности полупроводника в непосредственной близости от границы раздела.
 Уход электронов из приконтактной области электронного полупроводника приводит к тому, что их концентрация в этой области уменьшается (рис. 4.2, в). В результате заряд положительных доноров, то есть доноров, отдавших свой электрон в решетку, оказывается нескомпенсированным. Аналогично, уход дырок из приконтактной области дырочного полупроводника приводит к уменьшению в этой области концентрации дырок (рис. 4.2, в) и появлению нескомпенсированного заряда отрицательно заряженных ионов акцепторов. Вследствие этого около границы раздела возникает двойной слой электрических зарядов и электрическое поле между ними (рис. 4.2, г, д). Вектор напряженности Е этого внутреннего поля направлен от полупроводника n -типа к полупроводнику р -типа и является тормозящим для основных носителей и ускоряющим для неосновных. По мере перехода основных носителей заряда это поле усиливается и возрастает разность потенциалов между полупроводниками, вследствие чего потоки основных носителей уменьшаются. Потоки неосновных носителей при этом не меняются, поскольку они пропорциональны концентрации неосновных носителей. Так как изменение разности потенциалов не влияет на концентрацию неосновных носителей, то, следовательно, оно не влияет и на потоки неосновных носителей. Подобный процесс происходит до тех пор, пока потоки основных и неосновных носителей заряда не станут уравновешивать друг друга. При этом между полупроводниками установится контактная разность потенциалов Uк0, а величина внутреннего поля достигнет некоторого максимального значения Е i. Перепад потенциала Uк0 в переходе называют потенциальным барьером, поскольку он препятствует перемещению основных носителей заряда. Практически Uк0 ~ 0,3 – 0,7 В. Величина потенциального барьера зависит от температуры, при повышении температуры
Уход электронов из приконтактной области электронного полупроводника приводит к тому, что их концентрация в этой области уменьшается (рис. 4.2, в). В результате заряд положительных доноров, то есть доноров, отдавших свой электрон в решетку, оказывается нескомпенсированным. Аналогично, уход дырок из приконтактной области дырочного полупроводника приводит к уменьшению в этой области концентрации дырок (рис. 4.2, в) и появлению нескомпенсированного заряда отрицательно заряженных ионов акцепторов. Вследствие этого около границы раздела возникает двойной слой электрических зарядов и электрическое поле между ними (рис. 4.2, г, д). Вектор напряженности Е этого внутреннего поля направлен от полупроводника n -типа к полупроводнику р -типа и является тормозящим для основных носителей и ускоряющим для неосновных. По мере перехода основных носителей заряда это поле усиливается и возрастает разность потенциалов между полупроводниками, вследствие чего потоки основных носителей уменьшаются. Потоки неосновных носителей при этом не меняются, поскольку они пропорциональны концентрации неосновных носителей. Так как изменение разности потенциалов не влияет на концентрацию неосновных носителей, то, следовательно, оно не влияет и на потоки неосновных носителей. Подобный процесс происходит до тех пор, пока потоки основных и неосновных носителей заряда не станут уравновешивать друг друга. При этом между полупроводниками установится контактная разность потенциалов Uк0, а величина внутреннего поля достигнет некоторого максимального значения Е i. Перепад потенциала Uк0 в переходе называют потенциальным барьером, поскольку он препятствует перемещению основных носителей заряда. Практически Uк0 ~ 0,3 – 0,7 В. Величина потенциального барьера зависит от температуры, при повышении температуры  величина Uк0 снижается.
величина Uк0 снижается.
 Двойной электрический слой в области p - n перехода в основном создается зарядами доноров и акцепторов. Зарядами электронов, перешедших в р -область, и дырок, перешедших в n -область, можно пренебречь. Поскольку в p - n переходе концентрация электронов и дырок значительно меньше, чем за пределами перехода, его называют обедненным слоем. Этот слой обладает более высоким сопротивлением, чем соседние области. Ширина перехода
Двойной электрический слой в области p - n перехода в основном создается зарядами доноров и акцепторов. Зарядами электронов, перешедших в р -область, и дырок, перешедших в n -область, можно пренебречь. Поскольку в p - n переходе концентрация электронов и дырок значительно меньше, чем за пределами перехода, его называют обедненным слоем. Этот слой обладает более высоким сопротивлением, чем соседние области. Ширина перехода  очень мала, порядка нескольких десятых микрометра. Уровни Ферми в р - и n - областях совпадают
очень мала, порядка нескольких десятых микрометра. Уровни Ферми в р - и n - областях совпадают  , а концентрации неосновных носителей на границах p-n перехода имеют равновесные значения:
, а концентрации неосновных носителей на границах p-n перехода имеют равновесные значения:  ,
,  . Зонная схема p - n перехода в отсутствие напряжения на переходе показана на рис. 4.3, где
. Зонная схема p - n перехода в отсутствие напряжения на переходе показана на рис. 4.3, где  C – энергия дна зоны проводимости,
C – энергия дна зоны проводимости,  V – энергия потолка валентной зоны.
V – энергия потолка валентной зоны.
Электронно-дырочный переход
при наличии прямого напряжения
 Прямым напряжением называется внешнее напряжение U, которое, будучи приложенным к p - n переходу, снижает высоту потенциального барьера. При этом положительный полюс источника должен быть соединен с р -областью, а отрицательный – с n -областью (рис. 4.4, а). Поскольку p - n переход обладает более высоким сопротивлением, чем близлежащие области, можно считать, что все внешнее напряжение U приложено к p - n переходу и создает в нем электрическое поле, направленное навстречу внутреннему полю Е i. Вследствие этого уменьшаются величина потенциального барьера и ширина перехода ∆ x (рис. 4.4, б). Величина потенциального барьера UК становится равной
Прямым напряжением называется внешнее напряжение U, которое, будучи приложенным к p - n переходу, снижает высоту потенциального барьера. При этом положительный полюс источника должен быть соединен с р -областью, а отрицательный – с n -областью (рис. 4.4, а). Поскольку p - n переход обладает более высоким сопротивлением, чем близлежащие области, можно считать, что все внешнее напряжение U приложено к p - n переходу и создает в нем электрическое поле, направленное навстречу внутреннему полю Е i. Вследствие этого уменьшаются величина потенциального барьера и ширина перехода ∆ x (рис. 4.4, б). Величина потенциального барьера UК становится равной
 .
.
 При уменьшении величины потенциального барьера увеличивается количество носителей заряда, способных преодолеть его. Это ведет к увеличению потоков основных носителей заряда (потоки 1 и 2 на рис. 4.4, а). Потоки неосновных носителей не зависят от высоты потенциального барьера и сохраняются неизменными.
При уменьшении величины потенциального барьера увеличивается количество носителей заряда, способных преодолеть его. Это ведет к увеличению потоков основных носителей заряда (потоки 1 и 2 на рис. 4.4, а). Потоки неосновных носителей не зависят от высоты потенциального барьера и сохраняются неизменными.
Преобладание потоков 1 и 2 над потоками 3 и 4 ведет к инжекции электронов в р -область и дырок в n -область, в результате чего в области контакта возникают избыточные концентрации дырок и электронов (на рис. 4.4, в заштрихованы). При увеличении прямого напряжения высота потенциального барьера  снижается и возрастают потоки основных носителей, поэтому полный ток увеличивается. При этом края зон
снижается и возрастают потоки основных носителей, поэтому полный ток увеличивается. При этом края зон  и
и  в n -области поднимаются на величину eU относительно р -области, в окрестности перехода
в n -области поднимаются на величину eU относительно р -области, в окрестности перехода  , а концентрации носителей заряда удовлетворяют соотношениям:
, а концентрации носителей заряда удовлетворяют соотношениям:
 ,
,  . (4.1)
. (4.1)
Ток, протекающий через p - n переход при наличии прямого напряжения, называется прямым током.
Электронно-дырочный переход
при наличии обратного напряжения
Обратным напряжением, приложенным к полупроводниковому прибору, является внешнее напряжение, при котором происходит увеличение высоты потенциального барьера в p - n переходе. При этом положительный полюс источника соединяется с n -областью, а отрицательный – с р -областью. По-прежнему можно считать, что все внешнее напряжение прикладывается к приконтактной области. Это напряжение создает в переходе электрическое поле, направление которого совпадает с направлением внутреннего поля Е i. В результате высота потенциального барьера в переходе повышается и становится равной
 ,
,
а ширина перехода увеличивается. При достаточно большой величине обратного напряжения (порядка 1 В) потенциальный барьер становится настолько высоким, что потоки основных носителей 1 и 2 не преодолевают его. В этом случае через переход проходят только потоки неосновных носителей, не зависящие от высоты потенциального барьера.
Вольтамперная характеристика p-n перехода
 Вольтамперная характеристика показывает зависимость тока от приложенного к переходу напряжения. Распределение дырочных и электронных плотностей токов в p-n переходе показано на рис. 4.5. Верхний индекс означает, к какой области относится ток, нижний соответствует типу носителей заряда, образующим ток.
Вольтамперная характеристика показывает зависимость тока от приложенного к переходу напряжения. Распределение дырочных и электронных плотностей токов в p-n переходе показано на рис. 4.5. Верхний индекс означает, к какой области относится ток, нижний соответствует типу носителей заряда, образующим ток.
В р -области течет ток инжектированных электронов и ток дырок, следовательно:
 . (4.2)
. (4.2)
Аналогично в n -области течет ток инжектированных в нее дырок и ток электронов и выполняется равенство:
 . (4.3)
. (4.3)
Если рекомбинация в переходном слое пренебрежимо мала, то
 .
.
Полная плотность тока через переход с учетом этого условия записывается в виде
 . (4.4)
. (4.4)
Равенство (4.4) означает, что описание вольтамперной характеристики p-n перехода сводится к вычислению токов неосновных носителей на границе перехода.
Это можно сделать, предположив, что уровень инжекции носителей мал, то есть время жизни τр и длину диффузии LР дырок в n -области и, соответственно, τn и Ln в р -области можно считать постоянными.
Если токи через переход не слишком велики, то при вычислении  и
и  можно пренебречь дрейфом по сравнению с диффузией и использовать закон диффузии с коэффициентами диффузии Dp и Dn для дырок и электронов соответственно.
можно пренебречь дрейфом по сравнению с диффузией и использовать закон диффузии с коэффициентами диффузии Dp и Dn для дырок и электронов соответственно.
Для тока диффузии дырок в плоскости – x1:
 . (4.5)
. (4.5)
Аналогично для тока диффузии электронов в плоскости х2:
 . (4.6)
. (4.6)
Используя формулу (4.1), получаем:
 . (4.7)
. (4.7)
Следовательно, из формулы (4.4):
 . (4.8)
. (4.8)
Обозначая ток насыщения при обратном включении p-n перехода
 , (4.9)
, (4.9)
получаем вольтамперную характеристику p-n перехода (рис. 4.6, а):
 . (4.10)
. (4.10)
Так как сила тока i через диод пропорциональна плотности тока j, из соотношения (4.10) можно найти после преобразований линеаризованную ВАХ (рис. 4.6, б)
 . (4.11)
. (4.11)

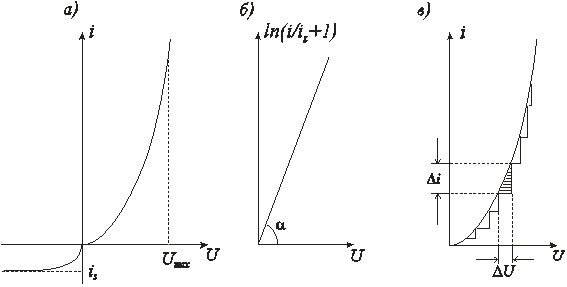
При этом угловой коэффициент линеаризованной ВАХ:
 . (4.12)
. (4.12)
Статические параметры диодов
Статические параметры диода характеризуют влияние напряжения на ток диода.
Одной из таких характеристик является дифференциальное сопротивление Rд. Оно характеризует изменение подводимого к диоду напряжения на величину тока
Rд = ∆ U /∆ i. (4.13)
По своему физическому смыслу Rд является внутренним сопротивлением диода переменному току. Это видно из следующих рассуждений. Если в формуле (4.13) принять приращения напряжения и тока равными соответствующим значениям амплитуд переменного напряжения Um и тока Im, то (4.13) принимает вид Rд = ∆ Um /∆ Im, что и является сопротивлением переменному току.
Для определения Rд на вольтамперной характеристике строят характеристический треугольник, катеты которого пропорциональны приращениям ∆ U и ∆ i (рис. 4.6, в). Величины ∆ U и ∆ i выбирают, с одной стороны, такими, чтобы их можно было достаточно точно измерить и, с другой стороны, они не должны быть очень большими, так чтобы гипотенуза характеристического треугольника была, по возможности, линейной. Рассчитанное по формуле (4.13) дифференциальное сопротивление является параметром для точки, расположенной посередине гипотенузы треугольника. Если построить систему таких характеристических треугольников, то для каждого из них можно найти свое дифференциальное сопротивление, а затем построить график зависимости Rд от приложенного внешнего напряжения.
Другой статической характеристикой является сопротивление диода постоянному току R0. Оно определяется соотношением R0 = U / i, где U и i – соответственно напряжение и ток в точке, для которой определяется R0. Дифференциальное сопротивление Rд диода и его сопротивление постоянному току R0 не равноценны, теоретически R0 = (3/2) Rд.
Date: 2015-05-19; view: 797; Нарушение авторских прав; Помощь в написании работы --> СЮДА... |