
Полезное:
Как сделать разговор полезным и приятным
Как сделать объемную звезду своими руками
Как сделать то, что делать не хочется?
Как сделать погремушку
Как сделать так чтобы женщины сами знакомились с вами
Как сделать идею коммерческой
Как сделать хорошую растяжку ног?
Как сделать наш разум здоровым?
Как сделать, чтобы люди обманывали меньше
Вопрос 4. Как сделать так, чтобы вас уважали и ценили?
Как сделать лучше себе и другим людям
Как сделать свидание интересным?

Категории:
АрхитектураАстрономияБиологияГеографияГеологияИнформатикаИскусствоИсторияКулинарияКультураМаркетингМатематикаМедицинаМенеджментОхрана трудаПравоПроизводствоПсихологияРелигияСоциологияСпортТехникаФизикаФилософияХимияЭкологияЭкономикаЭлектроника

Развитие полупроводниковых ключей
 |
Бурное развитие современной промышленной техники неразрывно связано с успехами энергетической или силовой электроники. Ее необходимость определяется большой потребностью в эффективных преобразователях и регуляторах электрической энергии. Характеристики и параметры силовых схем зависят от применяемых полупроводниковых приборов. Высокое качество полупроводниковых переключателей, их уникальные характеристики открывают перспективы совершенствования электронных устройств.
Энергетическая электроника предназначена для преобразования мощности, поэтому полупроводниковые элементы рассматриваются с точки зрения ключевого режима работы. Роль полупроводникового ключа заключается в коммутации различных частей схемы. Ключ должен обладать идеальными свойствами. Он должен мгновенно, при нулевой мощности управления, переключать бесконечно большие токи и блокировать бесконечно большие напряжения, иметь нулевое остаточное напряжение и токи утечки. Это возможно, при моделировании электронных схем на ЭВМ. Практические ключи могут лишь в той или иной степени приближаться к " идеальным "[1].
Разработка силовых ключей проходила поэтапно:
· С 40-х до 60-х годов были разработаны основные типы управляемых полупроводниковых ключей (биполярных и униполярных транзисторов и обыкновенных тиристоров). Повышение мощности приборов достигалось, за счет увеличения физических размеров структуры, что позволило обеспечить коммутируемые токи до 100 А и напряжение до 1000 В.
· В 70-х годах была разработана планарная технология, совершенствовались методы диффузии в полупроводниковые структуры и на базе вертикальных и многоканальных структур появились мощные биполярные и полевые транзисторы, способные рассеивать мощность в несколько ватт, затем были разработаны составные транзисторные и тиристорные ключи на дискретных элементах, сочетающих преимущества биполярных и полевых приборов.
· В 80-х годах были разработаны мощные гибридные модули с применением методов интегральной электроники. Появились совмещенные биполярно-полевые монолитные структуры. Коммутируемые токи составили сотни ампер и напряжения тысячи вольт. Тиристорные ключи стали полностью управляемыми с мегаваттным диапазон мощностей.
· Начало 90-х годов. Охарактеризовалось совершенствованием технологии, улучшением, качественных показателей ключевых приборов по быстродействию и остаточным напряжениям.
· Конец 90-х годов, характеризуется широким применением "интеллектуальных" приборов, субмикронных технологий, внедрением управляющих структур с изолированным затвором в структуры мощных тиристорных ключей. Наметилась тенденция по созданию универсального полупроводникового ключа, управляемого по изолированному затвору, с мощностью переключения, как у "тиристора", и остаточным напряжением, как прямое напряжение обычного диода.
В основу первых полупроводниковых ключей были положены теория выпрямления на границе р-п-перехода и открытие принципа полевого эффекта [2]. Исследования завершились созданием Бардиным и Браттеином в 1948 году точечного биполярного транзистора (рис. 1).
1949-1950г. Шокли на основе германия (Ge) разработал первый маломощный плоскостной биполярный транзистор - БТ (BJT - Bipolar Junction Transistor). В 1952 году был создан полевой транзистор с управляющим р-п-переходом - унитрон (Unipolar Transistor) (рис. 2).
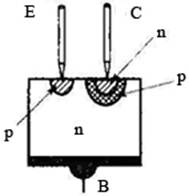
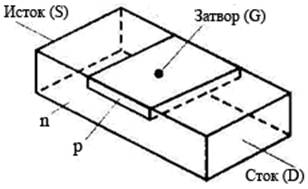
Рис.1 Рис.2
Первый маломощный транзистор со структурой металл-диэлектрик-полупроводник МДП (MOS - Metal Oxide Semiconductor Transistor) был предложен Хофстейном и Хейманом в 1963 году, с использованием интегральной технологии (рис. 3).

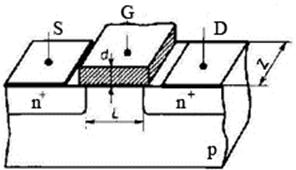 Основой первых силовых приборов становится кремний (Si), что позволило расширить температурный диапазон, увеличить пробивное напряжение и мощность приборов. В 1955 году под руководством Молла исследуются кремниевые приборы с тиратронной характеристикой (тиристоры). В 1958 году Тешнер повысил мощность униполярного транзистора за счет цилиндрической геометрии. (Текнетрон) (рис. 4).
Основой первых силовых приборов становится кремний (Si), что позволило расширить температурный диапазон, увеличить пробивное напряжение и мощность приборов. В 1955 году под руководством Молла исследуются кремниевые приборы с тиратронной характеристикой (тиристоры). В 1958 году Тешнер повысил мощность униполярного транзистора за счет цилиндрической геометрии. (Текнетрон) (рис. 4).
Увеличение размеров приборов с целью повышения тока и коэффициента усиления привело к ухудшению частотных свойств ключа. Увеличение площадей переходов и повышение допустимых напряжений увеличивали паразитные емкости и сопротивления каналов. В начале 60-х годов были изготовлены тиристоры на токи до сотен ампер и напряжения до 1000 В.

Рис. 4
 Добротность показатель качества транзисторного ключа, ее повышение возможно за счет уменьшения длины канала протекания тока.
Добротность показатель качества транзисторного ключа, ее повышение возможно за счет уменьшения длины канала протекания тока.  Добротность усилительного прибора равна произведению коэффициента усиления на полосу рабочих частот. У полевых транзисторов этот параметр прямо пропорционален передаточной крутизне и обратно пропорционален величине входной емкости затвора. Для биполярного транзистора добротность тем выше, чем меньше время пролета носителей. Вертикальная структура позволяет получить этот параметр на порядок больше по сравнению с планарными приборами. Одноканальная вертикальная структура уступала планарному аналогу по тепловым свойствам, поэтому было предложено применить вертикальные структуры приборов с множеством параллельных каналов (рис. 5). Первыми высокочастотными приборами, мощностью несколько ватт на частоте до 100 МГц, были униполярные транзисторы вертикального типа. В 1964 году Тешнер и Зулиг представили структуру гридистора (Gridistor) и многоканального полевого транзистора (Multi-Channel Field Effect Transistor (Рис 6). Японский специалист Нишидзава (Nishizawa J.) разработал статический индукционный транзистор - СИТ (SIT - Static Induction Transistor), способный управлять в диапазоне частот до 5 МГц. К началу 70-х годов, выделялись три основных типа транзисторов: -биполярные, -с управляющим p-n-переходом и МДП. Движение тока в биполярных транзисторах основано на явлениях инжекции, переноса и собирания носителей. В качестве основных носителей могут использоваться как электроны, так и дырки. Название приборов - биполярные – означает использование носителей разных полярностей. Тиристоры тоже относятся к биполярным ключам.
Добротность усилительного прибора равна произведению коэффициента усиления на полосу рабочих частот. У полевых транзисторов этот параметр прямо пропорционален передаточной крутизне и обратно пропорционален величине входной емкости затвора. Для биполярного транзистора добротность тем выше, чем меньше время пролета носителей. Вертикальная структура позволяет получить этот параметр на порядок больше по сравнению с планарными приборами. Одноканальная вертикальная структура уступала планарному аналогу по тепловым свойствам, поэтому было предложено применить вертикальные структуры приборов с множеством параллельных каналов (рис. 5). Первыми высокочастотными приборами, мощностью несколько ватт на частоте до 100 МГц, были униполярные транзисторы вертикального типа. В 1964 году Тешнер и Зулиг представили структуру гридистора (Gridistor) и многоканального полевого транзистора (Multi-Channel Field Effect Transistor (Рис 6). Японский специалист Нишидзава (Nishizawa J.) разработал статический индукционный транзистор - СИТ (SIT - Static Induction Transistor), способный управлять в диапазоне частот до 5 МГц. К началу 70-х годов, выделялись три основных типа транзисторов: -биполярные, -с управляющим p-n-переходом и МДП. Движение тока в биполярных транзисторах основано на явлениях инжекции, переноса и собирания носителей. В качестве основных носителей могут использоваться как электроны, так и дырки. Название приборов - биполярные – означает использование носителей разных полярностей. Тиристоры тоже относятся к биполярным ключам.
Принципы их работы хорошо иллюстрирует разработанная еще в начале 50-х годов двухтранзисторная модель Эбepca (Ebers J.). Униполярные (полевые) транзисторы с управляющим р-п-переходом, и со структурой МДП используют только основные носители заряда, движение которых управляется напряжением на затворе, т.е. электрическим полем. Отсутствие явления инжекции и необходимости рассасывания заряда неосновных носителей при выключении определило преимущество полевых транзисторов перед биполярными:
· Коэффициент усиления биполярных транзисторов из-за снижения коэффициента инжекции резко уменьшается в области больших токов. С ростом запираемого напряжения эта проблема усугубляется. Крутизна полевых транзисторов неизменна в области рабочих токов, что обеспечивает их устойчивость к токовым перегрузкам по сравнению с биполярными.
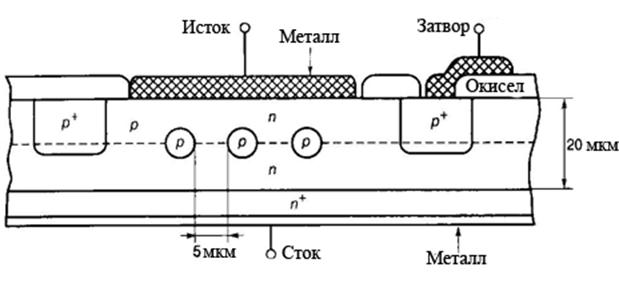
Рис. 6
· Значительные токи утечки у мощных биполярных транзисторов уменьшают область безопасной работы ключа. Большие токи управления с учетом снижения коэффициента усиления повышает мощность потерь в цепях управления биполярными приборами. Высокое входное сопротивление полевых транзисторов и малый динамический заряд управления значительно снижают эту мощность.
· Отсутствие накопленного заряда неосновных носителей обеспечивает высокую скорость переключения полевых транзисторов и лучшие динамические характеристики по сравнению с биполярными аналогами.
· Однородный полупроводник обладает положительным температурным коэффициентом сопротивления. Таким образом, полевой транзистор обладает теплоустойчивостью и способностью к самовыравниванию плотностей протекающего тока. В биполярных структурах в противоположность этому присутствует эффект локального перегрева. Таким образом, полевые транзисторы менее подвержены резким изменениям токовой нагрузки, что особенно ценно в многоканальных структурах.
На практике все оказалось не так просто.
· Напряжение насыщения высоковольтных биполярных транзисторов много меньше, чем полевых. Высокое сопротивление канала протекания тока, увеличивающегося с ростом пробивных напряжений, ограничили область использования полевых транзисторов устройствами высокочастотного применения и низковольтными (менее 100 В) схемами.
· Из-за высокого температурного коэффициента сопротивление открытого канала практически удваивается при температуре кристалла близкой к 150°С. Эта температура и оказалась критической для применения полевых транзисторов, тогда как биполярные приборы имели аналогичную температуру равную 200°С. Разность в 50°С, плюс снижение порогового напряжения с повышением температуры ограничили применение мощных полевых транзисторов при температуре окружающей среды близкой к 100°С.
Полученные результаты побудили разработчиков скомбинировать полезные свойства полевых и биполярных структур.
Задача заключалась в получении высоковольтного прибора с высоким входным сопротивлением и низким остаточным напряжением при сохранении высоких динамических показателей. Первые разработки были связаны с попытками приблизить характеристики биполярного ключа к полевому по схеме сдвоенного эмиттерного повторителя Дарлингтона (рис.7). В этой схеме коэффициент усиления равнялся произведению коэффициентов передачи составных транзисторов, и относительно большое входное сопротивление. Время выключения, составлявшее несколько мкс, на порядок и более уступало полевым транзисторам. Напряжение насыщения транзисторной сборки значительно увеличивалось с одновременным ростом потребляемой мощности. В 1978 году была разработана схема составного транзистора (рис.8), где в качестве управляющего ключа использовался мощный МДП-транзистор. Прибор, (побистор), сочетал свойства полевого и биполярного ключа, при незначительной мощности в цепи управления обеспечивал переключение тока в несколько десятков ампер при скорости переключения 200-400 нс. Аналогичные ключи использовались для управления приводом электродвигателей. Недостатки схемы связаны с низким коэффициентом усиления биполярного транзистора (для высоковольтных структур не более 10).


Рис. 7 Рис. 8
Другое направление представлено самосовмещенными монолитными структурами с МОП-затворами, выполненными методом двойной диффузии. Монолитные биполярно-полевые структуры изготовлены на основе вертикальной технологии ДМДП-транзисторов. В них реализовывалось совмещение функций полевого управления и биполярной проводимости. Аналогичное дискретной схеме побистора. В этих структурах наблюдался эффект потери управляемости после отпирания, эффект "защелкивания".
Применение технологической шунтировки эмиттерных переходов в самосовмещенной структуре позволило подавить нежелательный триггерный эффект и создать биполярный транзистор с изолированным затвором - IGBT (Insulated Gate Bipolar Transistor). Были разработаны приборы дискретного и модульного типов на токи от десятков до сотен ампер с напряжением блокировки до 1200 В. MOS-тиристоры фирмы "Motorola" к середине 80-х годов дополняются структурами с полевым запиранием - названные МСТ (MOS Controlled Thyristor) (рис. 9), отпираются и запираются полем при очень высоких плотностях тока (> 2000 А/см2). Разработка этих приборов столкнулась с серьезной проблемой - резким снижением допустимой плотности тока с ростом числа структурообразующих элементов. Значительно больших успехов достигла технология запираемых или двухоперационных тиристоров - GTO (Gate Torn-OffThyristor). Технологические успехи 80-х годов позволяют фирмам-изготовителям почти в 100 раз повысить мощность, переключаемую GТО (до 2500 А по току и 4500 В по напряжению). В зависимости от обратного блокирующего напряжения различают структуры без шунтировки анодного перехода и с шунтировкой, а также структуры со встроенным обратным диодом. Две последние обладают меньшим остаточным напряжением. Главное применение GTO в мощных высоковольтных цепях. В середине 80-х годов на запираемых тиристорах были разработаны инверторы напряжения для двигателей электровозов. Это позволило заменить на железнодорожном транспорте двигатели постоянного тока на более экономичные двигатели переменного тока, снизить энергопотребление и повысить эффективность перевозок.
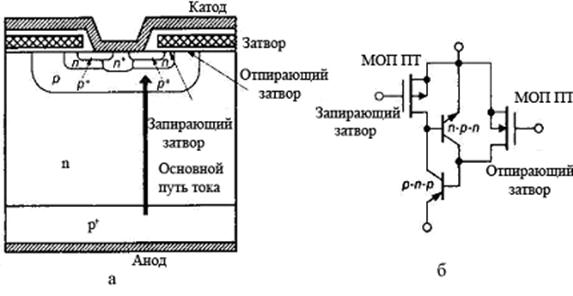
Рис. 9
Однооперационные тиристоры (SCR) занимают очень узкую нишу применения. Как правило, это высоковольтные линии электропередачи постоянного тока (ЛППТ). К концу 80-х годов предельные токи и напряжения тиристоров составляют 3000 А и 6000 В.
Конкуренцию запираемым тиристорам составляют индукционные тиристоры - ИТ (SITh - Static Induction Thyristor), разработанные на базе индукционных транзисторов в Японии и имели структуру, сходную с полевыми тиристорами FCT. Преимуществом индукционных тиристоров перед GTO является:
- отсутствие внутренней положительной обратной связи. Это повышает помехоустойчивость ключа и его рабочую температуру до 200°С;
- малое прямое падение напряжения при относительно высоких пробивных напряжениях;
- обладает положительным температурным коэффициентом;
- устойчив к большим импульсным перегрузкам по току. Параметры мощного ключа составляли 1500 А и 2500 В. К серьезному недостатку прибора относится его нормальная открытость, т.е. способность проводить ток при нулевом смещении на затворе. Это требует более сложной системы управления и снижает надежность применения.
Возрастающие требования экономии электроэнергии, повышения КПД систем силовой электроники, уменьшения их размеров, веса и стоимости выдвигали новые задачи по созданию высокоскоростных переключателей с минимальными потерями в широком диапазоне мощностей. Требовалась устойчивость ключевых приборов к перегрузкам по току, лавинному пробою, триггерному эффекту. Применение контроллеров в системах управления преобразователями накладывало дополнительные требования к характеристикам управляемости ключа.
Принцип работы новых типов полупроводниковых ключей и его физические характеристики заключены в структуре элементарной ячейки, из множества которых он затем собирается. А мощность, которую данный ключ способен переключать, зависит от размеров активной площади кристалла, на котором реализуется его многоячейковая структура. Чем сложнее структура элементарной ячейки, тем ближе ключ по своим характеристикам к идеалу, но тем труднее реализовать эту технологию на больших размерах активной площади. Это противоречие и лежит в основе многообразия типов полупроводниковых ключей:
- активная площадь кристалла ключевого прибора пропорциональна уровню предельного тока и пробивного напряжения. Этот фактор и лег в основу разделения технологий производства ключей по уровню напряжений;
- второй фактор, область применения прибора в системах тех или иных электронных сетей: бортовых, однофазных, трехфазных, контактных, электропередающих.
Для напряжений 50...100 В разработана технология высокочастотных МДП ключевых транзисторов. Они нашли широкое применение в преобразователях типа DC-DC для источников питания бортовых схем и устройств автомобильной электроники. Использовался метод плазменного травления. В пластине кремния создавались вертикальные канавки, заполняемые поликремнием (SiO2) используемые в качестве вертикального затвора. Этот технологический прием, получивший наименование "Trench", был применен и в более мощных транзисторах. Вертикальные канавки затвора позволили увеличить плотность размещения элементарных ячеек и снизить сопротивление открытого канала RON- Был введен параметр качества прибора - произведение сопротивления канала на площадь кристалла. Компания "Infineon Technologies", разработала технологию S-FET2 транзисторов с сопротивлением открытого канала 3 мОм на площади кристалла 30 мм2, которые могут использоваться в широком диапазоне токов от десятков до сотен ампер. В диапазоне мощностей от десятков до сотен ватт они вытеснили биполярные аналоги.
Для преобразователей электрической энергии типа AC/DC мощностью от сотен ватт до десятков киловатт разработаны транзисторы со структурой MOS, SIT и IGBT. В схемах, однофазной сети переменного тока, применялись транзисторы с пробивным напряжением до 600 В. В МДП-структурах проблема при таких напряжениях заключалась в снижении остаточного сопротивления. В 1998 году, фирма "Infineon Technologies" разработала технологию, получившую название CoolMOS. Создание глубокого сильнолегированного p-слоя позволило повысить показатель качества транзистора в 5 раз. И у них более низкие значения паразитных емкостей и по динамическим характеристикам они более чем в 3 раза превосходят стандартные аналоги.
Применение специальных разделительных канавок позволило разработать высокочастотные индукционные транзисторы с высоким коэффициентом усиления на напряжение 600 В (рис. 10). По сравнению с МДП-транзисторами последние имели значительно меньшую входную емкость. Однако высокое сопротивление открытого прибора (до единиц ом) и необходимость подачи отрицательного смещения ограничили применение СИТ областью токов до единиц ампер. Малые сопротивления открытого канала транзисторов достигались при прямой полярности напряжения на затворе. К недостаткам относится тепловая нестабильность и возможность теплового пробоя. Плотность тока в структурах IGBT значительно медленнее уменьшается с ростом рабочих напряжений, чем у МДП-транзисторов.
Главная задача при разработке таких транзисторов заключалась в уменьшении прямых падений напряжения и повышении их быстродействия. Включение дополнительного высоколегированного n+-слоя в структуру транзистора, названного буферным, позволило повысить уровень пробивных напряжений и скорость переключения. На напряжение классом 600 В была разработана целая серия IGBT-ключей с предельными токами в десятки и сотни ампер для диапазона частот 20... 100 кГц. К концу 90-х годов применяется уже третье поколение (рис. 11).
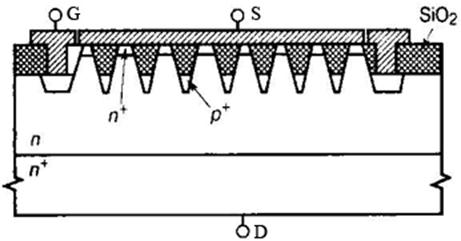
Рис. 10
Такая конструкция IGBT с буферным слоем называется эпитаксиальной, или структурой РТ (Punch-Through). Фирма "Siemens" разработала технологию однородной структуры, называемой гомогенной, или структурой NPT (Non-Punch-Through). РТ структура позволяет достигать более низких величин остаточного падения напряжения, особенно при пробивных напряжениях (до 600 В). РТ-, и NPT-структуры использовались при разработке IGBT-ключей с напряжением 1200В. Применение данных ключей в ШИМ-преобразователях с напряжением питания от 380 до 500В позволило увеличить преобразуемые мощности до сотен киловатт и вытеснить модули биполярных транзисторов. Дискретные IGBT-ключи класса 600 и 1200В 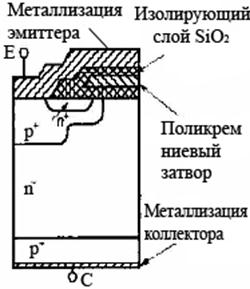 охватывают диапазон токов от единиц до десятков ампер и могут служить для реализации преобразователей мощностью не более 10 кВт. Диапазон рабочих токов IGBT расширяется до сотен ампер путем использования модульных конструкций отдельных, полумостовых и мостовых конфигураций. Новые технологии модульных ключей решают целый ряд задач. Одна из них связана с включением в модульную конструкцию согласованного с параметрами основного ключа демпферного диода FWD (Free Wheel Diode). Чтобы минимизировать
охватывают диапазон токов от единиц до десятков ампер и могут служить для реализации преобразователей мощностью не более 10 кВт. Диапазон рабочих токов IGBT расширяется до сотен ампер путем использования модульных конструкций отдельных, полумостовых и мостовых конфигураций. Новые технологии модульных ключей решают целый ряд задач. Одна из них связана с включением в модульную конструкцию согласованного с параметрами основного ключа демпферного диода FWD (Free Wheel Diode). Чтобы минимизировать  потери мощности при включении IGBT, диод должен иметь малый заряд восстановления и мягкий пробой обратной ветви ВАХ. Динамические характеристики диода лежат в диапазоне 100...300 нс. по времени восстановления и 0.5...2.5 мкКл по накопленному заряду. Другая задача связана с минимизацией паразитных индуктивностей корпуса. Специальные конструкции токоподводящих выводов позволили понизить величину паразитную индуктивность до 20...30 нГн. Для 600В и 1200В IGBT-ключей актуальной остается задача снижения остаточных напряжений и повышения быстродействия. Для класса напряжений 1200В фирмой "Tokin" выпущены статические индукционные транзисторы с токами 60... 180 А., которые используются в схемах резонансных инверторов для СВЧ печей мощностью 10...20 кВт.
потери мощности при включении IGBT, диод должен иметь малый заряд восстановления и мягкий пробой обратной ветви ВАХ. Динамические характеристики диода лежат в диапазоне 100...300 нс. по времени восстановления и 0.5...2.5 мкКл по накопленному заряду. Другая задача связана с минимизацией паразитных индуктивностей корпуса. Специальные конструкции токоподводящих выводов позволили понизить величину паразитную индуктивность до 20...30 нГн. Для 600В и 1200В IGBT-ключей актуальной остается задача снижения остаточных напряжений и повышения быстродействия. Для класса напряжений 1200В фирмой "Tokin" выпущены статические индукционные транзисторы с токами 60... 180 А., которые используются в схемах резонансных инверторов для СВЧ печей мощностью 10...20 кВт.
Высоковольтный диапазон от 1700 В. традиционно считался тиристорным. В 90-е годы были разработаны HV-структуры IGBT (High Voltage) на класс напряжений 1700 В. В основу ключа была положена гомогенная структура IGBT, выполненная по планарноэпитаксиальной технологии. Для защиты от пробоя использовалось поликристаллическое кремниевое охранное кольцо, которое уменьшало кривизну поверхностных полей. Для уменьшения остаточных напряжений в структуре оптимизировалось время жизни носителей. Ключи были разработаны в виде модулей на токи от 50 до 300 А и имели остаточное напряжение 2.5...4 В при частотах переключения до 50 кГц. Компания "Mitsubishi Electric" изготовила аналогичный ключ, используя эпитаксиальную структуру IGBT (рис. 12). Сравнение показало, что NPT-структуры имеют положительный температурный коэффициент во всей области рабочих токов, что позволяет создавать параллельные сборки на более высокие амплитуды тока. Однако РТ-структуры позволили при токе 400А уменьшить остаточные напряжения до 2.7В при аналогичных скоростях переключения.
Развитие полевых транзисторов с изолированным затвором МСТ, высоковольтных монолитных структур МСТ. на ток до 400 А. Данная структура содержит р-канальный отпирающий полевой транзистор (рис. 13). Такие ключи прерывают ток 100А, выдерживают dV/dt > 10000 В/мкс и продолжительность непрерывной работы более 100 часов при температуре перехода 250°С. Прямые падения напряжения в открытом состоянии при токе 400А составили 2.8 В. Динамические характеристики переключения по фронтам: около 200 не для включения и 600 не для выключения.
В конце 90-х годов появляются разработки HVIGBT и р-МСТ на напряжения 2500...3300 В. МСТ имели примерно двукратное преимущество по прямому падению напряжения. Энергия потерь при выключении IGBT на 30...50% меньше аналогичного показателя МСТ. Энергия потерь при включении определяется характеристикой демпферного диода. Для IGBT можно использовать последовательное сопротивление в цепи затвора, то МСТ не позволяет регулировать аналогичным образом скорость включения. Необходимо применять внешние защитные схемы, увеличивая дополнительные потери.
Полевые индукционные тиристоры - разработаны на токи 2200 А на основе кремниевой пластины диаметром 30 мм и способны блокировать напряжения 4000 В. В открытом состоянии индукционный тиристор работает как p-i-n-диод, он имеет меньшие прямые падения напряжения, чем другие тиристоры (при токе 400 А менее 2.3 В). Наступление комбинированных технологий на биполярные тиристоры. Заставило их двигаться дальше в область мегаваттных мощностей.

Рис. 12
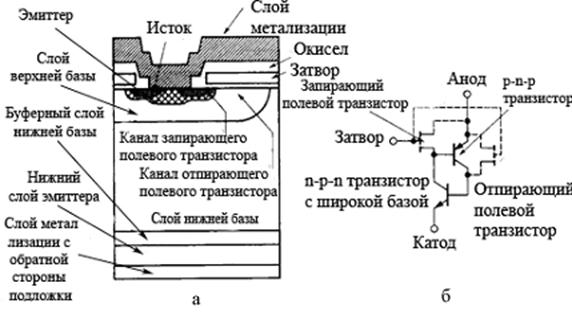
Рис. 13
По многоячейковой технологии на шестидюймовой кремниевой пластине и в специальном корпусе с молибденовыми дисками, отделяющими пластину от оснований анода и катода, компания "Mitsubishi Electric" разработала GTO на ток 6000А и напряжение 6000В (рис. 14). Коэффициент запирания у данного тиристора равен примерно 5...6 единиц, а время выключения по току порядка 5 мкс. Тиристор выдерживает ударные токи до 40000А и имеет остаточные падения напряжения не более 6 В. Эти уникальные достижения оказались возможными благодаря оптимизации процесса шунтировки анодного p-n-перехода и созданию неравномерного распределения времени жизни в области широкой n-базы. Однооперационные тиристоры сегодня изготавливаются на основе сверхвысоковольтной технологии (Ultra High Voltage) и имеют мощностные параметры 8000 В и 3600 А для линий передачи постоянного тока и 12000 В и 1500 А для статических переключателей переменного тока. Управляются подобные структуры импульсом света по специальному световолоконному кабелю (рис. 15). Общая диаграмма современного уровня силовых полупроводниковых ключей в координатах предельных токов, напряжений и частот представлена на рис. 16.
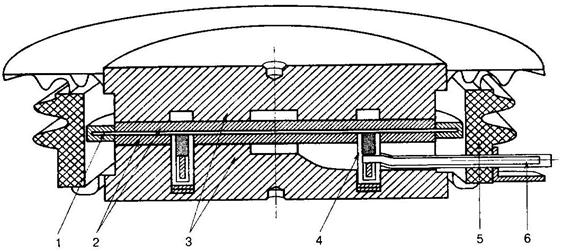
Рис. 14
Вывод. Совершенства достигли МДП-транзисторы технологии этих приборов в области относительно низких напряжений. С помощью "Trench”-технологии разработаны ячейки с ультранизким сопротивлением открытого канала. Напряжение транзисторов (OPTIMOS,) 30...75 В и ток до 80 А. Они имеют низкое сопротивление открытого канала, обладают минимальным тепловым сопротивлением (до 0.45 К/Вт) и повышенной плотностью размещения ячеек на единицу площади (1235 тысяч элементов на см2). Они обладают практически всеми свойствами идеального ключа, за исключением уровня пробивных напряжений.
· Объединение отдельных дискретных транзисторов позволило разработать интегральные структуры комбинированной проводимости и получить такие приборы, как IGBT и МСТ.
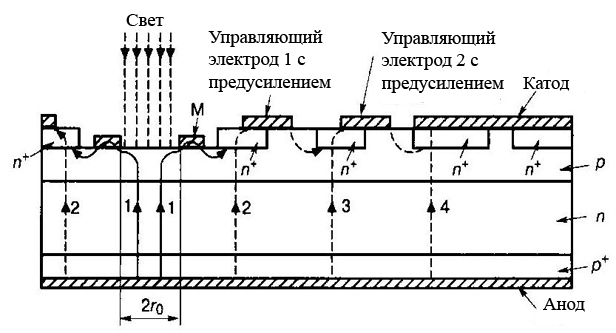
Рис. 15
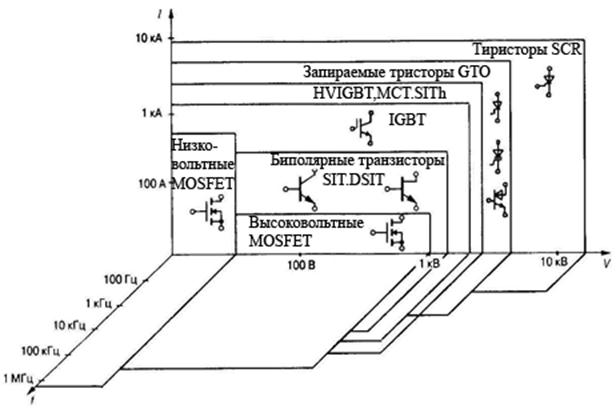
Рис. 16
Сейчас объединяют технологии. "Trench”-технология, вертикальное углубление затворных канавок начинает, применяется в мощных ключах. IGBT-ключей четвертого поколения. При этом размер элементарной ячейки был уменьшен до размеров менее одного микрона (рис. 17). Они обладают повышенной стойкостью к токовым перегрузкам, а их остаточные напряжения приближаются к параметрам диода (рис. 18). Модули транзисторов разработаны на токи 450 и 600 А для управления преобразователями лифтовых шахт. Замена МДП и биполярных модулей обеспечила уменьшение мощности потерь на 45%.
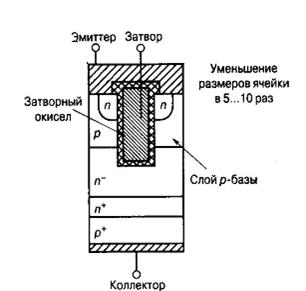
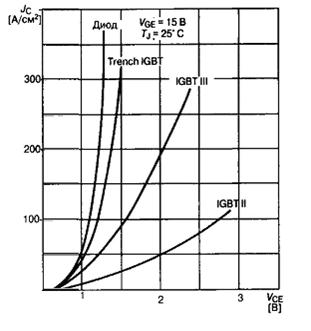
Рис. 17 Рис. 18
· Изготовленный с применением "Trench”-технологии FS-IGBT имеет остаточное напряжение менее 2 В и динамические потери на 20% меньшие по сравнению со стандартными аналогами
· Низковольтный и сильноточный n-канальный МДП-ключ с очень малым сопротивлением идеально подходит для структуры р-канального полевого тиристора в качестве запирающего элемента. Уже появились сообщения о разработке второго поколения МСТ на напряжение пробоя до 8000 В с плотностью анодного тока внутри структуры до 10000 А/см2.
· Недостаток индукционных тиристоров - нормально открытое состояние - преодолен разработкой монолитной структуры мощного комбинированного ключа, MOS Composite Static Induction Thyristor
(рис. 19). Роль управляющего элемента структуры выполняет низковольтный сильноточный МДП-транзистор. Эквивалентная схема этого комбинированного ключа практически совпадает с эквивалентной схемой IGBT-транзистора.
· Компанией Toshiba разработан новый полупроводниковый ключ Injection Enhanced Gate Tran-sistor (IEGT) на класс 4500 В и 750... 1500 А. Этот прибор имеет прямые напряжения и плотности тока, свойственные GTO-тиристорам, а динамические показатели - характерные для IGBT. Данные характеристики обеспечиваются специальной структурой ячейки с широким затвором. В ближайшей перспективе - разработка IEGT на рабочее напряжение 6000 В. Планарная структура IEGT имеет площадь кристалла порядка 1.2 см2. В корпусе прибора располагается 15 подобных кристаллов совместно с 6 кристаллами диодов. В качестве опытных образцов изготовлены IEGT с "Trench”-структурой и площадью кристалла 0.69 см2 на тот же класс рабочих напряжений и токов (рис. 20).
Применение перспективного полупроводникового материала - карбида кремния позволит уменьшить сопротивление эпитаксиальных слоев и увеличить пробивные напряжения МДП-структур до 5000 В. На основе карбида кремния компанией "Siemens AG" разработана вертикальная структура полевого транзистора JFET (Junction Field Effect Transistor) (материал 4H-SiC) с блокирующим напряжением 1800В, а также структура n-канального МДП-транзистора (материал 6H-SiC). Каскадное соединение данного JFET с обычным низковольтным МДП-транзистором позволяет получить новый ключевой прибор с хорошими статическими и динамическими характеристиками (остаточное напряжение менее 1.5 В, время переключения менее 100 нс., рабочая температура более 250°С). Данный транзистор способен выдерживать токовую нагрузку в течение длительного времени (до 1 мс) (рис. 21). Обратный диод в структуре 6H-SiC МДП-транзистора обладает высокими динамическими характеристиками восстановления (обратный заряд менее 30 нКл и время восстановления обратного тока менее 20 нс.).
· Разработана технология CoolMOS С2 МПД-структур с новой геометрией затвора, позволившая в 3 раза повысить скорость выключения транзистора и уменьшить динамические потери на 50%.
· Переход мощных ключей на управление с поликремниевым затвором прослеживается и в новых разработках GTO-тиристоров.
В будущем GТО и МСТ, как самые мощные управляемые тиристорные ключи придут к единой структуре. Будут управляться мощным МДП-ключом. Например, IGBT и индукционные тиристоры. Для их управления с поликремниевым затвором надо отказаться от токового управления. Перейти от формирования запирающего тока при выключении GТО к простому выключению обратным смещением. Разработанные фирмой "Mitsubishi Electric" структуры с переключением тока, GCT-тиристоры (Gate Commutated Turn-off Thyristor). По своей структуре сходные с GTO-тиристорами, обладают возможностью переключать основной ток в цепи электрода управления с последующим запиранием основной структуры. Формирователь управления представляет собой конденсатор, разряд которого запирает ключ по затвору. Полное переключение тока GCT-тиристора позволяет отказаться от применения снабберов и ограничиться только схемой фиксации уровня. Общие потери понизились в 2 раза. Серия ключей FG4000HX-90DS имела предельные токи и напряжения 3000 А и 4500 В. Чтобы переключить такой уровень тока в цепь электрода управления, формирователь должен иметь на входе быстродействующий ключ с очень низким сопротивлением в открытом состоянии. Это еще один пример применения МДП-транзисторов при управлении ключами большой мощности. GCT сочетается с блоком формирования импульсов управления в единой конфигурации.
· Усложнение структуры силовых ключей и ряд требований по их управлению и защите привели к созданию специальных электронных схем согласования между логической частью устройств и входом самого прибора - драйверов или формирователями импульсов управления (Driver).
Успехи в области микронных технологий и развитие принципа управления по затвору стимулировали разработку "разумных" ключей (SMART-технология) и силовых интеллектуальных модулей IPM (Intelligent Power Modules).
На одном кристалле объединены силовой ключ и управляющая схема. Но только решение проблемы оптимизации размещения элементов на общей поверхности кремниевого кристалла, применение поверхностного монтажа, а также методов изоляции позволили разработать "разумные" ключевые устройства.
Таким образом, наиболее отработанная в области малых напряжений МДП-структура продолжает интеграцию в область больших мощностей в качестве управляющей.

Рис. 19, а
Совмещенная со структурой биполярного транзистора, эта конструкция позволила получить IGBT-прибор четвертого поколения с высокими динамическими характеристиками и напряжением открытого состояния, близким к диоду.
Современные технологии развития вновь приводят нас к диоду, но уже на более совершенной ступени, где диод является управляемым по поликремневому затвору.
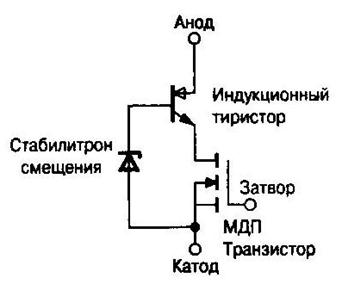
Рис. 19, б
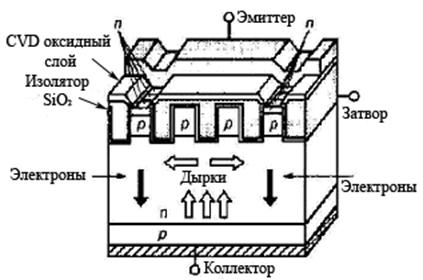
Рис. 20
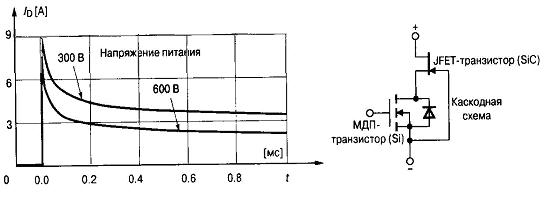
Рис. 21
ТЕМА 1. Элементная база силовой электроники
 |
Рассмотрение структуры мощных ключевых приборов позволяет более наглядно представить принцип действия самого ключа и тех физических процессов, которые лежат в основе его работы. Схемотехническое описание базовой ячейки в виде эквивалентной электрической схемы позволяет учесть взаимное влияние полупроводникового ключа и устройства применения, сформулировать основные принципы управления данным прибором и способы его защиты. Структуры элементарных ячеек рассматриваются в виде сочетания переходов различных слоев кремниевого полупроводникового материала с электронной (п) и дырочной (р) проводимостью.
Если концентрации основных носителей различаются более чем на порядок, переходы называются односторонними и обозначаются символами типа р+ -n, р-n+ и т.п., где знаки "+" и "-" указывают на высокую или, соответственно, низкую степень легирования полупроводникового слоя.
1.1 Вольтамперные характеристики электронных ключей в различных режимах работы.
Статические режимы работы ключей.
 Статическим режимом работы ключа называется установившийся после переключения режим его работы в одном из следующих состояний: включенном (проводящем) или выключенном (непроводящем).
Статическим режимом работы ключа называется установившийся после переключения режим его работы в одном из следующих состояний: включенном (проводящем) или выключенном (непроводящем).
Динамические режимы работы ключей.
 Динамическим режимом работы ключа называется его работа в процессе перехода из одного состояния (например, включенного) в другое (например, выключенного) и наоборот.
Динамическим режимом работы ключа называется его работа в процессе перехода из одного состояния (например, включенного) в другое (например, выключенного) и наоборот.
Динамические ВАХ называют также траекториями переключения (коммутации) электронного ключа. Переходные процессы в ключах зависят от быстродействия и параметров элементов электронной цепи.
Диаграммы напряжения  и тока
и тока  такой модели представлены выражениями:
такой модели представлены выражениями:
 ;
;
 ,
,
где  и
и  – установившиеся значения напряжения и тока до и после коммутации соответственно;
– установившиеся значения напряжения и тока до и после коммутации соответственно;  и
и  – время включения и выключения электронного ключа (справочное).
– время включения и выключения электронного ключа (справочное).
Средняя мощность потерь в ключе может быть представлена двумя составляющими  и
и  . Составляющая
. Составляющая  соответствует статическому режиму, а
соответствует статическому режиму, а  - динамическому (т.е. переходу ключа S из одного состояния в другое). Эти составляющие, согласно Рис. 1.1, определяются следующими соотношениями:
- динамическому (т.е. переходу ключа S из одного состояния в другое). Эти составляющие, согласно Рис. 1.1, определяются следующими соотношениями:
 ;
;
 .
.
Суммарные средние потери мощности в ключе, переходящие в тепловую энергию, будут равны сумме этих составляющих, т.е.  и
и  .
.

Рис. 1.1
Date: 2015-05-09; view: 2617; Нарушение авторских прав; Помощь в написании работы --> СЮДА... |